椭偏仪与DIC系统联用测量半导体超薄图案化SAM薄膜厚度与折射率
超薄膜的表征技术对确定半导体薄膜材料(如金属、金属氧化物、有机薄膜)的最佳性能至关重要。本研究提出将微分干涉相衬DIC系统与椭偏仪联用表征超薄图案化自组装单分子膜(SAM):通过DIC实时提供高对比度图像指导测量位置,结合改进的椭偏分析模型,实现对图案化SAM薄膜厚度与折射率的高精度无损表征。费曼仪器薄膜厚度测量技术贯穿于材料研发、生产监控到终端应用的全流程,并且公司自研的Flexfilm全光谱椭偏仪可以做到对薄膜的厚度与折射率的高精度表征。
材料与方法
图案化FDTS(1H,1H,2H,2H-全氟癸基三氯硅烷)样品采用标准半导体工艺制备,包括光刻、SAM气相沉积和去胶技术。
DIC成像
DIC系统通过沃拉斯顿棱镜将45°偏振入射光分裂为两束正交偏振光,这两束光在样品表面因局部厚度或折射率差异产生光程差(相位差);随后,光程差经另一沃拉斯顿棱镜重组,并通过135°检偏器转换为干涉强度信号——无光程差区域形成暗场像,而存在光程差区域则呈现亮场像或彩色像。通过横向位移棱镜可主动调节光程差,从而增强透明弱对比样品(如纳米级SAM/SiO₂图案)的显微对比度,实现超薄膜结构的精准定位与可视化。

(a) DIC-椭偏仪联用系统示意图;(b) 传统模型(模型1)与改进模型(模型2)流程对比
椭偏仪测量
相较于传统方法(模型1),我们开发了改进模型(模型2)用于计算SAM层的厚度和折射率(RI):
传统模型(模型1):通常引入SiO₂柯西模型或预设A=1.45的柯西模型作为拟合模型。SAM膜的折射率被固定为SiO₂柯西模型或预设A=1.45的柯西模型值。首先,使用SiO₂柯西模型获得单层SiO₂的厚度T。然后,使用相同模型(SiO₂柯西或预设A=1.45的柯西模型)测量SAM+SiO₂层的厚度T₁。最终,SAM厚度(TSAM = T₁ - T)由T₁与T的差值得到。
改进模型(模型2):基于模型1,同样通过差值法得到SAM厚度(TSAM = T₂ - T,其中T₂为SAM+SiO₂层厚度,T为SiO₂层厚度)。随后,利用已知的TSAM拟合SAM层的柯西系数。最终,使用这些柯西系数获得更准确的SAM膜折射率。
结果与讨论
DIC精准定位
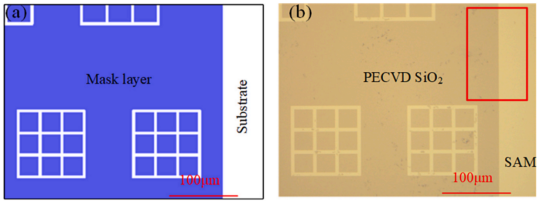
(a) 掩模图案;(b) DIC图像(亮区:SAM,暗区:SiO₂),红框为测量区域
通过高对比度DIC成像成功区分FDTS SAM图案(亮区)与SiO₂基底(暗区),并基于厚度-亮度关联性在400 μm × 300 μm区域内系统选定10个均匀分布采样点(含明/暗区域),为椭偏仪提供精确测量定位。
改进模型验证
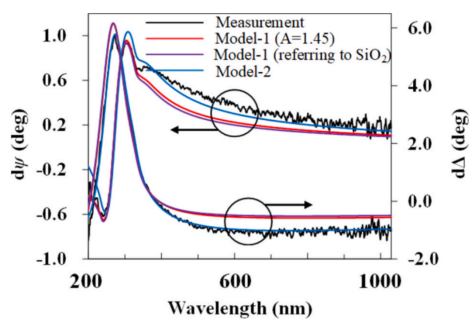
差示光谱的实测值与模型模拟曲线对比(模型2最优)
差分光谱分析(dψ = ψSiO₂+SAM - ψSiO₂, dΔ = ΔSiO₂+SAM - ΔSiO₂)显示,改进模型(模型2) 的模拟曲线与实测值高度吻合。
传统模型(模型1) 因固定折射率(RI=1.45)或强制关联SiO₂光学参数,导致光谱显著偏离实测值,证实其描述超薄SAM的局限性。
厚度与折射率结果
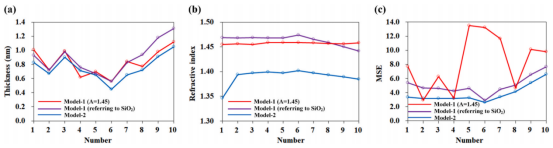
模型2在10个采样点的厚度/折射率结果及MSE对比(优于模型1)
Model-2测得SAM层平均厚度0.89 ± 0.50 nm,平均折射率1.387 ± 0.030。
对比结果:
Model-1(固定RI=1.45):厚度0.75 ± 0.30 nm, RI 1.463 ± 0.040
Model-1(关联SiO₂):厚度0.83 ± 0.40 nm, RI 1.457 ± 0.003
数据可靠性验证:
厚度一致性:Model-2结果与AFM测量值仅差0.2 nm,且接近文献报道的~1 nm厚度。
RI合理性:1.387的RI值符合文献中FDTS单层折射率下限(≥1.29)。
拟合优度:Model-2的均方误差(MSE)显著低于Model-1,证明其建模准确性。
本研究通过微分干涉相衬(DIC)系统引导非破坏性椭偏测量,成功表征超薄图案化自组装单分子膜(SAM)。开发了基于柯西模型的改进拟合方法(模型2),测得SAM平均厚度为 0.89 nm,折射率为 1.387,与原子力显微镜(AFM)及文献数据一致。该技术为半导体超薄图案化薄膜提供了一种高精度非破坏性表征方案。

技术支持:180-1566-6117
全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)
✔ 先进的旋转补偿器测量技术:无测量死角问题。
✔ 粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
✔ 秒级的全光谱测量速度:全光谱测量典型5-10秒。
✔ 原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm全光谱椭偏仪能非破坏、非接触地原位精确测量超薄图案化薄膜的厚度、折射率,结合费曼仪器全流程薄膜测量技术,助力半导体薄膜材料领域的高质量发展。
原文参考:《Dic-guided ellipsometer to characterize ultrathin patterned films with an improved fitting model》