台阶仪/椭偏仪在不同半导体关键工序中的计量技术与应用
随着半导体技术向高集成度与高性能方向不断发展,工艺尺寸持续缩小,制造工艺对膜厚、线宽、台阶高度及电阻率等关键参数的测量精度提出了更高要求。然而,半导体测量设备在实际应用中面临量值溯源体系不完善、测量结果不一致等突出问题,直接影响工艺控制的准确性与器件性能的可靠性。Flexfilm探针式台阶仪可以实现表面微观特征的精准表征与关键参数的定量测量,精确测定样品的表面台阶高度与膜厚,为材料质量把控和生产效率提升提供数据支撑。
本文通过系统研究台阶仪、椭偏仪、扫描电子显微镜和四探针测试仪等典型测量设备的计量方法,分析其量值溯源中的关键要素,提出构建多维度计量数据模型库,并建立基于数据的设备管控决策机制,从而为实现测量设备的精准溯源、科学管理与全生命周期控制提供有效解决方案,推动工艺质量提升与良率优化。
测量设备与工艺对应关系

典型测量设备与对应工艺
半导体工艺流程复杂,涵盖晶圆制备、沟槽光刻、沟槽刻蚀、薄膜沉积、离子注入、抛光、金属化及封装测试等环节。每道工序均需配备专用测量设备,以监控关键参数。
典型设备计量技术
台阶仪
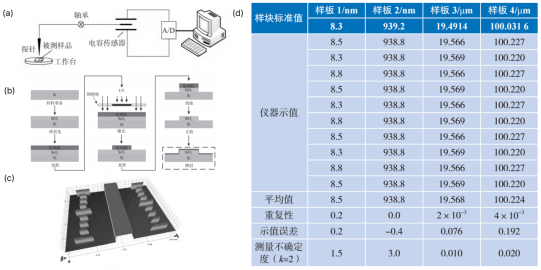
(a)台阶仪测量原理(b)台阶高度样板(c)台阶高度样板三维图像(d)台阶仪校准数据
台阶仪为接触式表面形貌测量设备,通过探针在样品表面移动,感知高度变化,转换为电信号并重建轮廓。其校准依赖于台阶高度标准样板,该样板经光刻、刻蚀、溅射等工艺制成,具备已知高度与良好表面特性。
校准过程中,采用激光干涉仪或原子力显微镜对台阶高度进行定值,依据JJF129—2017规范评价仪器的示值误差与重复性。
椭偏仪
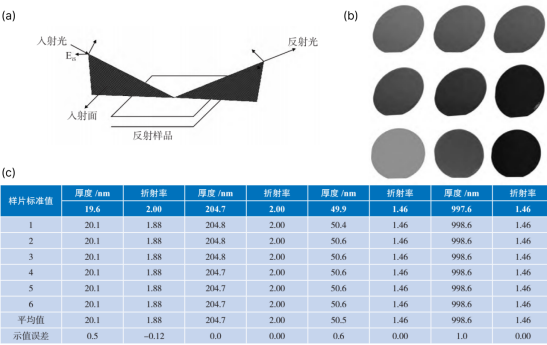
(a)椭偏仪测量原理(b)研制的 2~1 000 nm 膜厚标准样片(c)椭偏仪校准数据
椭偏仪通过分析偏振光在薄膜表面的反射行为,获取薄膜厚度与折射率。其校准采用氧化法制备的膜厚标准样板,定值设备包括XPS与光谱型椭圆仪。
校准依据JJG14—2011,重点评估膜厚与折射率的测量准确度。
扫描电子显微镜(SEM)
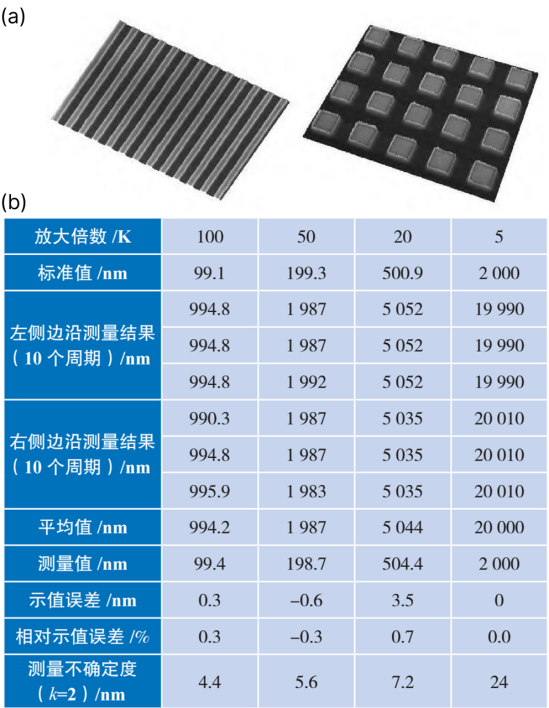
(a)线距样板:左-竖栅,右-格栅(b)X 向测量示值误差
SEM通过电子束扫描样品表面,收集二次电子等信号成像,用于微纳尺度图形测量。其校准采用线距标准样板,通过原子力显微镜或可溯源SEM进行定值。
校准依据JJF 1351—2012,评估测长示值误差、正交畸变等参数。
四探针测试仪

(a)四探针测试仪测量原理(b)方阻示值误差
四探针测试仪采用直流四探针法测量电阻率,通过外侧探针注入电流,内侧探针检测电压,计算得出电阻率值。校准采用掺杂硅片作为电阻率标准样板,通过标准电流源与纳伏表实现溯源。校准依据JG 508—2004,主要评价方阻示值误差,典型误差控制在3%以内。
计量管控决策机制
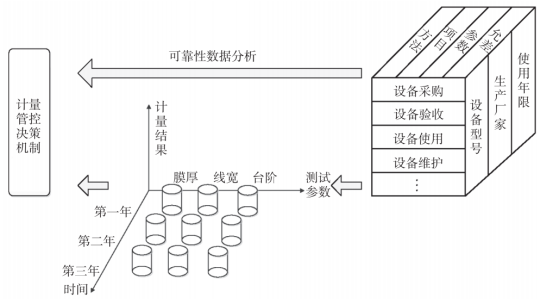
基于数据的计量技术管控体系决策机制思路
为实现设备全生命周期管理,提出基于数据的计量技术管控体系。该体系通过采集多维度计量数据与设备运行状态信息,构建计量数据模型库,集成至质量管理平台。系统能够自动评估设备重复性、稳定性,识别关键参数,制定科学校准周期与应急响应机制,为设备采购、验收、使用与维护提供决策支持。
半导体测量设备的准确性与可靠性直接关系到工艺控制水平与产品良率。本文系统阐述了台阶仪、椭偏仪、SEM与四探针测试仪等典型设备的计量方法与溯源体系,并提出构建数据驱动的计量管控机制,为半导体制造企业提升工艺控制能力与设备管理水平提供技术参考。未来,随着工艺节点不断推进,计量技术将继续朝着更高精度、更强溯源性与更智能化的方向发展。

技术支持:180-1566-6117
在半导体、光伏、LED、MEMS器件、材料等领域,表面台阶高度、膜厚的准确测量具有十分重要的价值,尤其是台阶高度是一个重要的参数,对各种薄膜台阶参数的精确、快速测定和控制,是保证材料质量、提高生产效率的重要手段。
✔ 配备500W像素高分辨率彩色摄像机
✔ 亚埃级分辨率,台阶高度重复性1nm
✔ 360°旋转θ平台结合Z轴升降平台
✔ 超微力恒力传感器保证无接触损伤精准测量
费曼仪器作为国内领先的薄膜厚度测量技术解决方案提供商,Flexfilm探针式台阶仪可以对薄膜表面台阶高度、膜厚进行准确测量,保证材料质量、提高生产效率。
原文参考:《典型半导体工艺测量设备计量技术》