椭偏仪在精密薄膜中的应用:基于单驱动变角结构的高重复性精度控制系统
椭偏测试技术具有非接触、高灵敏、无样品破坏优势,广义椭偏仪因可测各向同性与异性样品成研究热点,但需变角结构实现多角度测量。当前立式椭偏仪存在双电机配合难或装配精度高问题,卧式椭偏仪光路不易对准,且缺乏低成本、高集成度且精确变角控制的方案。Flexfilm全光谱椭偏仪可以非接触对薄膜的厚度与折射率的高精度表征,广泛应用于薄膜材料、半导体和表面科学等领域。
本文提出单驱动变角式椭偏仪,设计其变角结构与补偿器运动部件,经测试,空气透射式测量重复性精度 < 0.014,121.5nm 标准 SiO₂薄膜样片多角度反射测量 < 0.040,为低成本、易控制的椭偏仪设计提供新方案。
单驱动变角结构设计

单驱动变角式椭偏仪结构示意图
为解决当前广义椭偏仪变角结构 “杆件多、设计复杂、控制精度要求高、光路难对准” 的问题,本文提出的单驱动变角结构,核心由起偏臂、检偏臂、样品台三部分组成,采用 “固定起偏臂,同步旋转检偏臂与样品台” 的方式实现多角度测量。
根据光学反射原理,当样品台与检偏臂的转速比为 1:2 时,能恰好保证椭偏测量系统的光路准直,这是该结构实现精准测量的关键设计点。
双旋转补偿器式椭偏测量原理
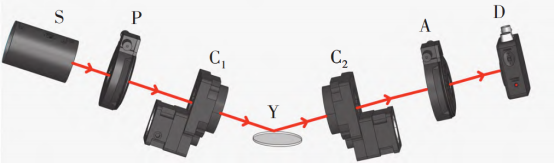
双旋转补偿器式广义椭偏仪测量原理图
双旋转补偿器式椭偏测量的核心原理,是通过 “调制 - 反射 - 解调 - 采集” 的流程获取样品参数:
光源发出的光束经起偏器(P)与补偿器 C₁调制,转化为偏振光;
偏振光经样品(Y)表面反射后,偏振态发生改变;
改变后的偏振光经补偿器 C₂与检偏器解调,再由探测器(D)采集光信号;
通过分析光束反射前后的光强变化,可计算出样品的 16 个穆勒矩阵元素,进而得到样品的光学参数(如厚度、折射率)。
双旋转补偿器运动控制
补偿器 C₁与 C₂的 “同步同方向旋转” 是精准测量穆勒矩阵元素的核心前提。采用一个4相步进同步电机,通过同步传动机构,按照预设的1:2转速比,同时带动检偏臂和样品台旋转至上位机指定的入射角度(如30°、45°、60°、75°)。
上位机软件集成
基于LabVIEW平台开发了图形化人机交互控制界面。该界面集成了四大功能区域:
初始化配置区: 用于设置测量参数与系统初始化。
变角结构控制区: 实现入射角的精确设定与控制。
补偿器运转控制区: 控制双补偿器的启停、转速与同步。
数据读取区: 实时显示与保存探测器采集的光强数据。
实验验证与性能分析
为评估所搭建系统的可行性与测量精度,进行了严格的重复性测试。测试样品与方法:
空气样本: 采用透射式测量;标准SiO₂薄膜样片(厚度121.5 nm): 采用反射式测量,并在30°、45°、60°、70°四个入射角下进行。每个测量条件下均重复10次,以评估其重复性精度。
评价指标:采用重复性精度(δ)作为关键性能指标,其计算公式为:

x¡为单次测量值(n=10)
结果与讨论

空气样本10次测量光强变化图

透射式10次测量重复性精度变化图
空气样本测试: 10次透射测量的归一化光强曲线高度重合。对所有360个采样点计算出的重复性精度均小于0.014,证明了系统在理想透射条件下具有极佳的稳定性与重复性。

四个角度光强值变化图

4个角度10次测量重复性精度变化图
SiO₂薄膜样片测试: 在多角度反射测量中,系统同样表现出良好的重复性。各角度下360个采样点的重复性精度均满足:30° < 0.040,45° < 0.025,60° < 0.035,70° < 0.035。总体而言,多角度反射测量的重复性精度优于0.040。
性能对比分析: 反射测量精度略低于透射测量,其主要原因是激光经样品反射后光强发生显著衰减,导致环境噪声和探测器本身的相对误差增大,从而对测量重复性造成了影响。这在光学测量中是常见的现象。
本文成功设计并实现了一套用于单驱动变角式椭偏仪的控制系统。通过对变角结构和双补偿器进行精密的运动控制设计,并集成友好的上位机软件,解决了传统椭偏仪在结构复杂性和光路对准方面的部分难题。重复性实验结果表明,该系统在透射与多角度反射测量模式下均能达到良好的重复性精度(透射<0.014,反射<0.040)。该研究为开发低成本、易控制、结构紧凑的椭偏仪提供了一种有效的技术方案和设计思路。
Flexfilm全光谱椭偏仪

技术支持:180-1566-6117
全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)。
▶先进的旋转补偿器测量技术:无测量死角问题。
▶粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
▶秒级的全光谱测量速度:全光谱测量典型5-10秒。
▶原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm全光谱椭偏仪能非破坏、非接触地原位精确测量超薄图案化薄膜的厚度、折射率,结合费曼仪器全流程薄膜测量技术,助力半导体薄膜材料领域的高质量发展。
原文参考:《单驱动变角式广义椭偏仪的控制系统设计》