基于光学成像的沉积薄膜均匀性评价方法及其工艺控制应用
静电喷涂沉积(ESD)作为一种经济高效的薄膜制备技术,因其可精确调控薄膜形貌与化学计量比而受到广泛关注。然而,薄膜的厚度均匀性是影响其最终性能与应用可靠性的关键因素,其优劣直接受到电压、流速、针基距等多种工艺参数的复杂影响。传统均匀性评估方法往往效率较低或具有破坏性,难以满足快速工艺优化的需求。Flexfilm探针式台阶仪可以实现表面微观特征的精准表征与关键参数的定量测量,精确测定样品的表面台阶高度与膜厚,为材料质量把控和生产效率提升提供数据支撑。
本研究提出并建立了一种基于光学图像分析的快速、非破坏性均匀性定量评估方法。该方法将半透明薄膜置于均匀光源上,通过数码相机获取透射光图像,并依据朗伯-比尔定律将灰度信息转换为厚度分布。通过自主开发的图像处理算法,从宏观(基于厚度方差的区块分析)和微观(基于厚度梯度的分布统计)两个尺度对均匀性进行量化评价,从而实现对薄膜质量的高通量、全场表征,为工艺参数的系统优化提供了直接、有效的分析工具。
实验方法
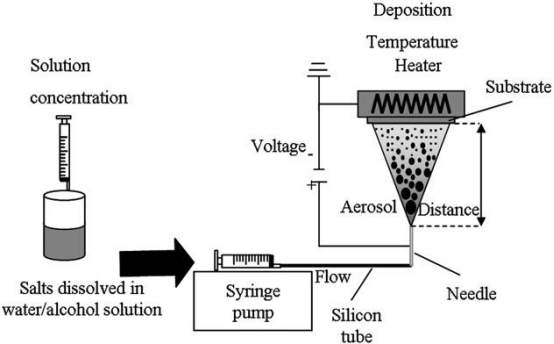
用于制备薄膜的静电喷涂沉积装置示意图
薄膜制备
以CuCl₂·2H₂O、InCl₃和硫脲为前驱体,配制水-醇基溶液,在SnO₂:F导电玻璃基板上进行ESD沉积。系统研究了溶液浓度(0.21–0.49 M)、电压(10–20 kV)、流速(25–200 µL/min)、针 基距(4–5 cm)及基板温度(380–450°C)对薄膜形貌的影响。
均匀性评估流程
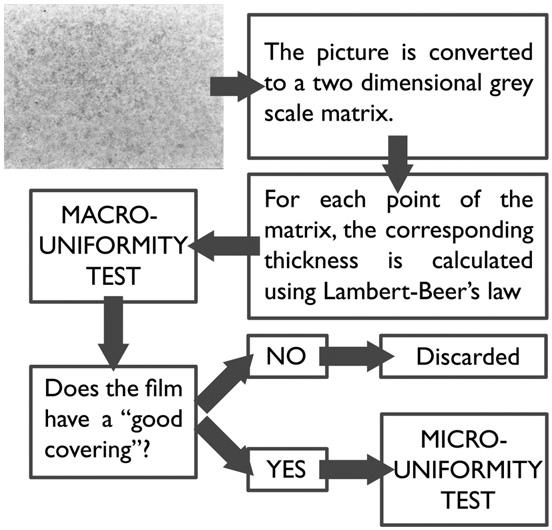
宏观均匀性测试流程图
图像采集:将半透明薄膜置于均匀光源上,通过数码相机获取透射光图像。
厚度转换:将图像转换为灰度矩阵,并依据朗伯 比尔定律,假设固定吸收系数(10⁻⁵ cm⁻¹),将灰度值换算为相对厚度分布。
两段式分析:

左:人工生成图像(用于验证MUT);右:MUT对人工图像的分析结果
宏观均匀性测试(MUT):将厚度矩阵划分为不同尺寸的区块,计算各区块平均厚度的方差。随着区块尺寸减小,方差的变化趋势反映了薄膜在大尺度上的厚度波动。设定方差阈值(μ(t) ≤ 10⁻¹² @ 200像素区块)可用于快速筛选均匀性合格的样品。
微观均匀性测试(μUT):对通过MUT的样品,计算厚度矩阵在行、列方向上的梯度分布,并统计其半高宽(FWHM)。FWHM越小,表明薄膜局部厚度变化越平缓,微观均匀性越好。

样品的喷涂沉积条件
实验结果

左:不同条件下样品的数字图像;中:宏观均匀性测试(MUT)结果;右上:微观均匀性测试(μUT)结果;右下:计算粗糙度与台阶仪测量粗糙度对比图
通过对多组工艺条件下制备的薄膜进行分析,结果表明:
较高的电压(16–20 kV)与适中的流速(100–200 µL/min)有利于获得宏观均匀的薄膜。
微观均匀性最佳的样品(如2号样品)表现出最窄的厚度梯度分布(FWHM ≈ 3.95 nm)。
该方法计算的厚度分布粗糙度与台阶仪的测量结果趋势一致,验证了其可靠性。相较于轮廓仪的单点测量,图像分析法能提供全视野的平均信息,对不均匀样品更具表征优势。
静电喷涂沉积(ESD)是一种可在低温下制备可控薄膜的灵活技术。高电场的使用减少了材料损失,有利于优化薄膜性能。通过调整实验参数可改善沉积薄膜形貌。本文开发的测试方法简单有效,可用于评估薄膜厚度均匀性。对于成分均匀的薄膜,该方法通过分析图像亮度变化反映厚度均匀性;也可用于监测成分变化引起的局部光学密度差异。该方法无损、高效,基于图像处理与分析实现均匀性量化。尽管本研究针对ESD薄膜,但同样适用于其他沉积技术制备的半透明薄膜。

技术支持:180-1566-6117
在半导体、光伏、LED、MEMS器件、材料等领域,表面台阶高度、膜厚的准确测量具有十分重要的价值,尤其是台阶高度是一个重要的参数,对各种薄膜台阶参数的精确、快速测定和控制,是保证材料质量、提高生产效率的重要手段。
✔ 配备500W像素高分辨率彩色摄像机
✔ 亚埃级分辨率,台阶高度重复性1nm
✔ 360°旋转θ平台结合Z轴升降平台
✔ 超微力恒力传感器保证无接触损伤精准测量
费曼仪器作为国内领先的薄膜厚度测量技术解决方案提供商,Flexfilm探针式台阶仪可以对薄膜表面台阶高度、膜厚进行准确测量,保证材料质量、提高生产效率。
原文参考:《A method to quantify the degree of uniformity of thickness of thin films》