椭偏仪微区成像光谱测量:精准表征二维ReS₂/ReSe₂面内双折射率Δn≈0.22
二维过渡金属硫族化合物ReS₂和ReSe₂因其晶体结构中的“铼链”而具备显著的面内光学各向异性,在偏振敏感光电器件中展现出重要潜力。然而,其微米级样品在可见光波段沿不同晶轴的关键光学参数(如折射率、消光系数)尚缺乏系统的定量表征,传统光谱椭偏仪因空间分辨率不足而难以实现微区精确测量。Flexfilm全光谱椭偏仪可以非接触对薄膜的厚度与折射率的高精度表征,广泛应用于薄膜材料、半导体和表面科学等领域。
本研究发展了基于成像光谱椭偏仪的高分辨率微区分析方法,通过旋转样品获取沿a轴与b轴的椭偏参数,进而提取完整的光学常数谱,并分析其双折射与二向色性行为。该方法不仅填补了该材料体系光学参数数据库的空白,也为各向异性二维材料在光学调制等器件中的设计提供了直接依据。
样品制备与表征
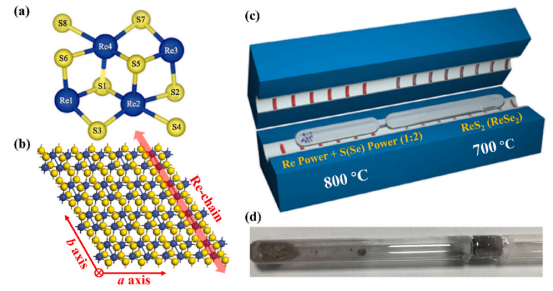
(a)ReS₂单胞结构示意图(b)ReS₂晶体结构俯视图(c)CVT法生长ReS₂与ReSe₂单晶示意图(d)所使用的石英管及所得ReSe₂单晶照片
采用化学气相输运法制备 ReS₂ 与 ReSe₂ 单晶,随后通过机械剥离获得二维纳米薄片。剥离前对 Si/SiO₂ 衬底进行标记与氧等离子体处理,以增强衬底与材料间的范德华作用力。利用原子力显微镜获取样品厚度与表面形貌,XRD 分析确认其晶体结构与取向。通过显微拉曼光谱仪(配备可旋转半波片)进行偏振拉曼测量,研究声子模式的各向异性行为。
成像光谱椭偏仪系统
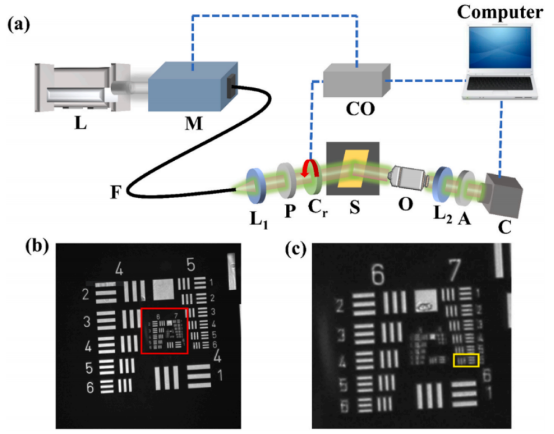
(a)成像光谱椭偏仪结构示意图(b)ISE对分辨率校准板的成像照片(c)图(b)中红色框选取区域的放大视图

R3L3S1N 1951 USAF分辨率校准板的分辨率参考值(单位:μm)
系统光源为氙灯,经单色仪产生 400–700 nm单色光,依次通过准直镜、起偏器与旋转补偿器,再经物镜与成像透镜组成的显微放大系统照射样品。反射后的椭圆偏振光经过检偏器,由 CMOS 相机接收光强信号,通过 Matlab 进行 Hadamard 分析与傅里叶系数计算,最终解调得到椭偏参数 Ψ 与 Δ。系统经 USAF 1951 分辨率板校准,在 700 nm 波长下分辨率可达 2.19 μm,适用于尺寸为数十微米的二维材料研究。
样品形貌与结构表征
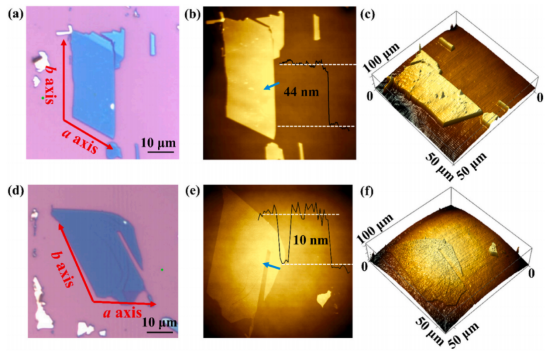
样品的显微图像、平面图及三维立体图(a)(b)(c):ReS₂(d)(e)(f):ReSe₂

(a)二维ReX₂的XRD扫描谱(b)二维ReX₂的拉曼光谱,标注了振动模式
AFM 显示 ReS₂ 与 ReSe₂ 薄片厚度分别为 44 nm 与 10 nm,表面平整且结构完整。XRD 谱仅出现 (000) 系列衍射峰,表明样品具有良好的 c 轴取向且无杂相。拉曼光谱在 50–450 cm⁻¹范围内出现多个声子峰,对应 ReX₂ 的 Ag、Eg等振动模式,与理论计算及文献结果一致,证实样品质量良好。
偏振拉曼各向异性分析

(a)ReS₂拉曼强度随半波片旋转角度的分布(b)ReSe₂拉曼强度随半波片旋转角度的分布(c)–(f)两个Eg模式的偏振依赖性
通过旋转入射光偏振方向,观察到多个拉曼峰强度随角度呈现周期性变化,其中低频 Eg 模式的偏振依赖性尤为显著,进一步证实了材料的面内各向异性。
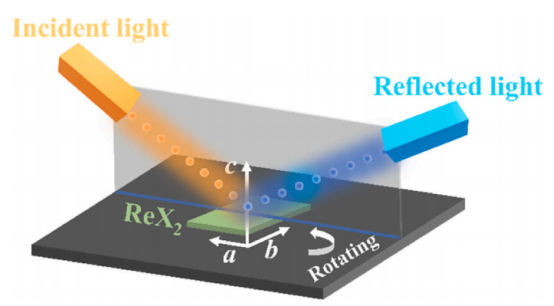
对包含a轴与b轴的样品表面进行MIE测量的示意图
椭偏测量与光学参数提取
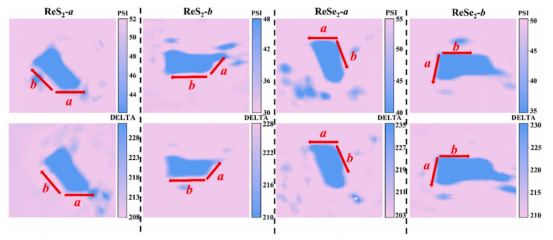
二维ReX₂在不同光轴方向(波长450 nm处)的椭偏参数

(a)(b)系统精度验证(c)–(f)实测与拟合椭偏光谱对比
利用成像光谱椭偏仪,通过旋转样品使入射面分别与 a 轴和 b 轴对齐,获取沿不同方向的椭偏参数。系统先经衬底各向同性验证与商业椭偏仪对比,确认测量可靠性。采用 Levenberg-Marquardt 算法对 Ψ 与 Δ 进行拟合,均方误差结果良好,拟合厚度与 AFM 测量结果接近。
光学各向异性分析
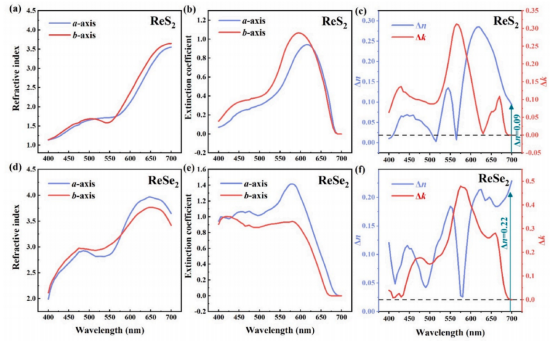
二维ReX₂沿不同光轴方向的折射率、消光系数及其双折射与二向色性
折射率与消光系数谱显示,两种材料在400–700 nm范围内均表现出明显的各向异性。在 600–700 nm 红光区域,沿 a 轴与 b 轴的折射率差异尤为显著。消光系数在约 600 nm 出现峰值,ReSe₂ 的吸收边沿不同方向差异较大,而 ReS₂ 相对较小。计算得到的双折射(Δn)与二向色性(Δk)表明,ReS₂ 与 ReSe₂在近700 nm处 Δk 趋近于零,Δn 分别为0.09与0.22,可用于光学相位调制元件的设计。
介电函数与能带结构关联
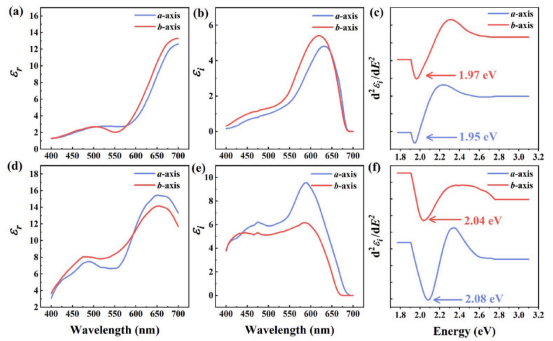
二维ReX₂的介电函数谱及其虚部二阶导数谱
通过复折射率计算得到介电函数谱,其虚部二阶导数反映了带间跃迁能量。结果表明,ReS₂ 沿 b 轴的跃迁能量高于 a 轴,而 ReSe₂ 则相反,这与吸收强度的各向异性趋势一致。结合已有角分辨光电子能谱研究,说明不同晶向上的原子排列与电子结构差异是引起光学各向异性的主要原因。
本研究利用高分辨率成像光谱椭偏仪,系统表征了机械剥离二维 ReS₂ 与 ReSe₂ 沿 a 轴与 b 轴的光学参数,揭示了其显著的面内光学各向异性。通过偏振拉曼与椭偏分析相结合,不仅验证了材料的结构各向异性,更为其折射率、消光系数、介电函数等关键光学参数的数据库提供了重要补充。所发展的微区成像椭偏方法为今后各向异性二维材料的光学表征与器件设计提供了有效的技术支撑。

技术支持:180-1566-6117
全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)。
▶先进的旋转补偿器测量技术:无测量死角问题。
▶粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
▶秒级的全光谱测量速度:全光谱测量典型5-10秒。
▶原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm全光谱椭偏仪能非破坏、非接触地原位精确测量超薄图案化薄膜的厚度、折射率,结合费曼仪器全流程薄膜测量技术,助力半导体薄膜材料领域的高质量发展。
原文参考:《Study of in-plane optical anisotropy of two-dimensional ReS2 and ReSe2
based on imaging spectroscopic ellipsometry》