椭偏仪在半导体的应用|不同厚度m-AlN与GaN薄膜的结构与光学性质
Ⅲ族氮化物半导体是紫外至可见光发光器件的关键材料。传统c面取向材料因极化电场导致量子限制斯塔克效应,降低发光效率。采用半极性(如m面)生长可有效抑制该效应,尤其(11-22)取向在实现高铟掺入InGaN量子阱方面优势显著。然而,半极性薄膜在异质外延中面临晶体质量差、应力各向异性等挑战。Flexfilm全光谱椭偏仪可以非接触对薄膜的厚度与折射率的高精度表征,广泛应用于薄膜材料、半导体和表面科学等领域。
本章采用MOCVD方法在m面蓝宝石衬底上生长了不同厚度的AlN和GaN薄膜,并利用椭圆偏振光谱、XRD、OT、PL 和 Raman 等多种手段,系统研究了薄膜厚度对其晶体质量、光学性质、应力状态及缺陷行为的影响。
实验方法
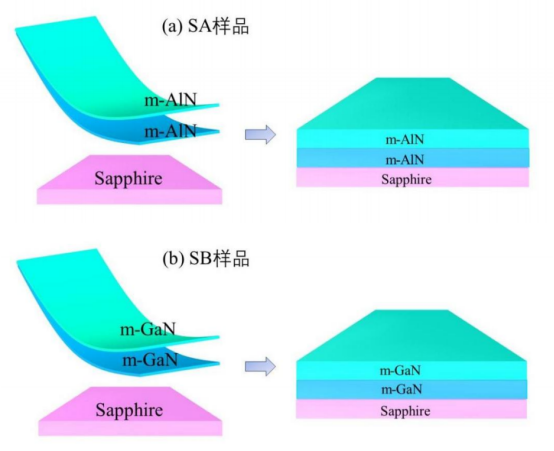
(a)m-AlN和(b)m-GaN样品结构示意图
采用金属有机化学气相沉积在m面蓝宝石衬底上生长样品:
AlN系列:通过氨脉冲流工艺生长,外延层设计厚度分别为1 μm (SA1)、2 μm (SA2)、3 μm (SA3)。
GaN系列:采用连续流工艺生长,外延层设计厚度分别为900 nm (SB1)、1800 nm (SB2)、2700 nm (SB3)。
利用高分辨率X射线衍射、Flexfilm全光谱椭偏仪、光学透射谱、光致发光谱及拉曼光谱进行系统表征。
m-AlN薄膜厚度效应

A:室温时,3片m-AlN样品测试(彩色实线)与模型拟合(黑色虚线)的Ψ(λ)和Δ(λ)光谱;B:通过SE测试得到三个m-AlN样品外延层与光子能量的关系图;C:m-AlN样品SE拟合数据分析结果;D:室温下三个样品的拟合光学常数(折射率n和消光系数k)
晶体质量:XRD分析表明所有样品均沿(11-22)方向外延生长。随厚度增加,(11-22)衍射峰强度增强,半高宽减小(SA1: 1.107°→SA3: 0.569°),显示晶体质量显著提升。
光学特性:椭圆偏振光谱拟合显示表面粗糙度从SA1的2.86 nm降至SA3的2.72 nm。光学带隙约为5.9 eV,Urbach带尾能量随厚度增加而降低(SA1: 366 meV→SA3: 300 meV),表明结构无序度减小。
光学透射谱在透明区显示清晰法布里-珀罗振荡,佐证薄膜均匀性良好。
应力与缺陷:
拉曼光谱中E₂(High)模峰位变化显示,SA1为拉应力状态,SA2、SA3转为压应力,且压应力随厚度增加。
E₂(High)模半高宽减小(8.58→5.49 cm⁻¹),表明缺陷密度降低。
光致发光光谱中,深能级缺陷发光峰位从391 nm蓝移至385 nm,强度减弱,说明氧相关缺陷随厚度增加而减少。
m-GaN薄膜厚度效应

A:室温时,3片m-GaN样品测试(彩色实线)与模型拟合(黑色虚线)的Ψ(λ)和Δ(λ)光谱;B:m-GaN样品E拟合数据分析结果;C:通过SE测试得到三个m-GaN样品外延层与光子能量的关系图;D:室温下三个样品的拟合光学常数(折射率n和消光系数k)
结构特性:XRD结果确认(11-22)取向生长成功。衍射峰半高宽随厚度增加逐渐减小(SB1: 1.207°→SB3: 1.141°),结晶质量改善。
光学性质:
椭圆偏振光谱拟合获得的光学带隙分别为3.391 eV (SB1)、3.398 eV (SB2)、3.408 eV (SB3)。
表面粗糙度从1.02 nm降至0.81 nm。
发光性能:
光致发光谱显示本征发光峰位于3.42 eV附近,Voigt拟合识别出自由激子发射及其声子伴峰(FX-1LO与FX-2LO)。
随着厚度增加,FX-1LO与FX-2LO的强度比值从2.50增至3.42,表明晶体质量提升。
应力状态:拉曼光谱中E₂(High)模显示所有样品均处于压应力状态,但应力值随厚度增加略有降低,同时该模半高宽减小(4.71→4.46 cm⁻¹),反映缺陷减少。
厚度影响晶体质量的机理
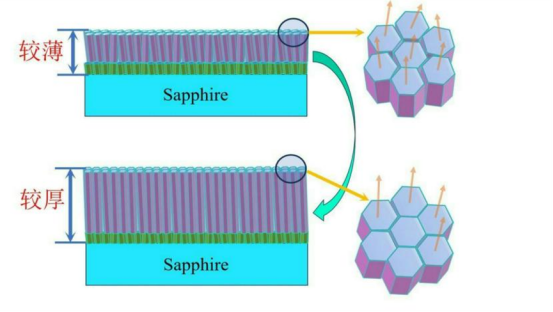
薄膜厚度增加后薄膜晶体质量提升的示意图
生长初期,由于衬底与薄膜间的晶格失配,缓冲层中晶粒排列无序、缺陷密度高。随着外延层厚度增加,晶粒逐渐融合并沿晶体学方向有序排列,晶界处的位错与缺陷通过延伸、相互作用或湮灭而减少,从而显著提升薄膜的整体结晶质量。
本章通过 MOCVD 方法在m面蓝宝石上成功生长了不同厚度的半极性AlN和GaN薄膜。系统研究表明,随着薄膜厚度增加:晶体质量显著提升:XRD 半高宽减小,表面粗糙度降低;光学性质改善:Urbach 带尾能量降低,缺陷发光峰蓝移且强度减弱;应力状态演变:AlN 由拉应力转为压应力,GaN 压应力随厚度略有弛豫;发光性能优化:GaN 本征发光峰强度比随厚度增加而增大。研究建立了“厚度增加—缺陷减少—质量提升”的物理模型,为半极性氮化物薄膜在光电器件中的应用提供了重要的实验依据与理论支持。

技术支持:180-1566-6117
全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)。
▶先进的旋转补偿器测量技术:无测量死角问题。
▶粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
▶秒级的全光谱测量速度:全光谱测量典型5-10秒。
▶原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm全光谱椭偏仪能非破坏、非接触地原位精确测量超薄图案化薄膜的厚度、折射率,结合费曼仪器全流程薄膜测量技术,助力半导体薄膜材料领域的高质量发展。
原文参考:《Ⅲ族氮化物半导体薄膜的结构和光学性质研究》