SiOₓ薄膜的无损表征:新型光学建模方法提升光谱椭偏测量精度
光谱椭偏(SE)作为一种基于偏振光分析的非接触、无损表征技术,已被广泛应用于薄膜光学参数的精确测量。然而,当前该技术主要侧重于提取厚度、折射率等基础光学量,对SiOx等非化学计量薄膜的深层物理化学性质(如组分、结构)缺乏系统的分析能力,限制了对薄膜性能与工艺之间关联的深入理解。Flexfilm费曼仪器全光谱椭偏仪可以非接触对薄膜的厚度与折射率的高精度表征,广泛应用于薄膜材料、半导体和表面科学等领域。
本研究提出了一种进阶的光学建模策略:首先采用Tauc-Lorentz色散模型精确标定非晶硅(a-Si)与二氧化硅(SiO₂)的光学常数;进而基于Bruggeman有效介质近似模型,将SiOx薄膜等效为a-Si与SiO₂的复合介质,通过拟合椭偏光谱反演出其厚度、有效光学常数、组分体积比及化学计量数x。该方法通过多种传统表征手段(轮廓仪、光谱仪、XPS等)的交叉验证,证实了其可靠性与准确性,从而将SE从常规光学测量拓展为一种能够深入解析薄膜成分与结构的强大工具,为非化学计量功能薄膜的工艺优化与性能研究提供了有效方法。
实验方法

椭偏表征示意图
![]()
溅射制备薄膜的固定工艺参数

溅射制备薄膜的实验参数(A组:不同氧分压;B组:不同溅射功率)
采用中频磁控溅射系统,在玻璃及硅衬底上沉积a-Si、SiO₂及SiOₓ薄膜。选用Si-Al(8 vol% Al)烧结靶以提升溅射稳定性。通过调节氧分压(0–1.5%)与溅射功率(175–275 W)调控薄膜组成与结构。利用光谱椭偏仪(300–1200 nm)采集椭偏数据,结合Tauc-Lorentz色散模型拟合获得a-Si与SiO₂的光学常数(n, k)。在此基础上,将SiOₓ薄膜视为a-Si与SiO₂的混合体系,采用BEMA模型拟合其椭偏光谱,从而同时获取薄膜厚度、光学常数及组分体积分数。通过轮廓仪、紫外-可见-近红外分光光度计、FTIR及XPS对SE结果进行系统验证。
a-Si与SiO₂的光学表征
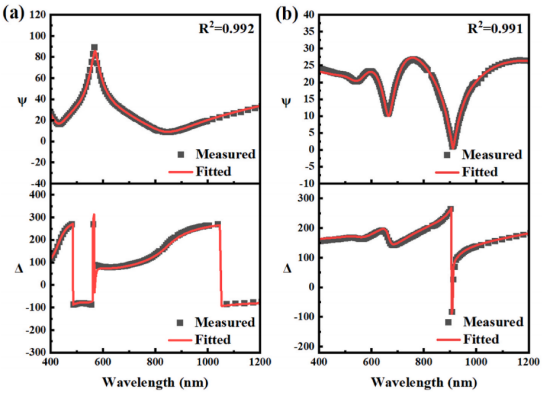
(a) a-Si和(b) SiO₂薄膜的实验测量与拟合Ψ和Δ值
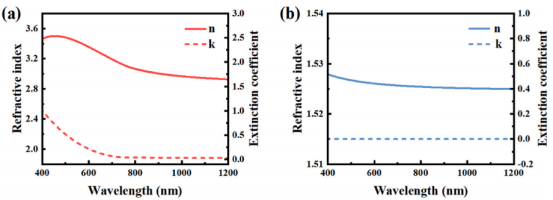
(a) a-Si和(b) SiO₂薄膜的折射率与消光系数

(a) a-Si的透射谱与(b)反射谱;(c) SiO₂的透射谱与(d)反射谱。散点:实验测量值;曲线:计算值

a-Si与SiO₂薄膜的厚度测量结果对比
Tauc-Lorentz模型对a-Si和SiO₂的椭偏数据拟合优度(R² > 0.99)极高,提取的折射率与消光系数与文献值一致。SE测得的薄膜厚度与轮廓仪结果差异小于1%,验证了SE厚度测量的可靠性。基于拟合光学常数计算的透反射光谱与实验测量值高度吻合,证实了模型在描述材料光学行为方面的准确性。
SiOₓ薄膜的BEMA分析
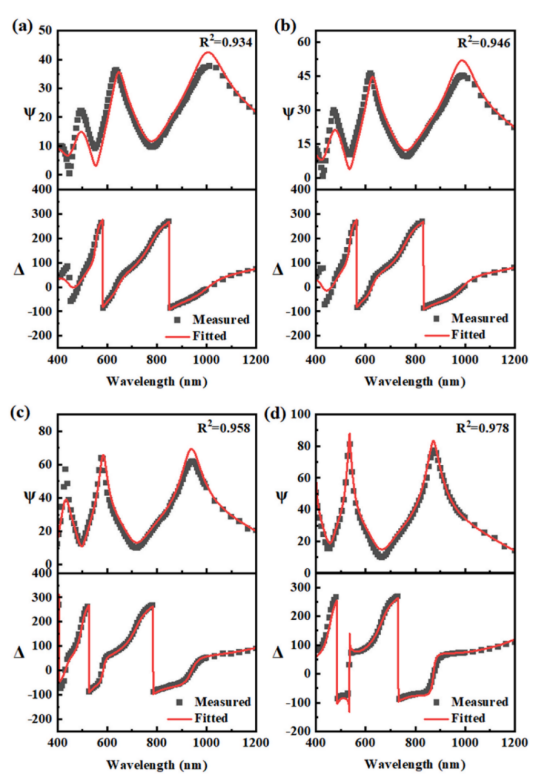
A组(不同氧分压)SiOₓ薄膜在氧分压为(a) 0.2%、(b) 0.5%、(c) 1%和(d) 1.5%时的实验测量与拟合Ψ和Δ值

SiOₓ薄膜的光学常数。(a) A组的n和k;(c) B组的n和k;(b) A组在550 nm处的折射率;(d) B组在550 nm处的折射率。实线:折射率;虚线:消光系数

(a) A组和(b) B组所有薄膜的实验测量与拟合厚度;(c) A、B两组沉积速率的柱状图
BEMA模型成功拟合了不同工艺条件下SiOₓ薄膜的椭偏光谱。分析表明:随着氧分压升高,薄膜折射率与消光系数系统性下降;而随着溅射功率增大,两者呈线性上升趋势。这反映了薄膜中Si与SiO₂相对含量的变化:高氧分压促进氧化,形成更多SiO₂相(低n,低k);高溅射功率则增加硅原子通量,有利于富硅相(高n,较高k)形成。同时,溅射功率提高也增强了离子轰击效应,可能提升薄膜致密度,进一步贡献于折射率升高。SE反演的薄膜厚度与沉积速率变化趋势与轮廓仪及SEM结果一致,且与工艺参数具有明确关联。
组分分析与交叉验证
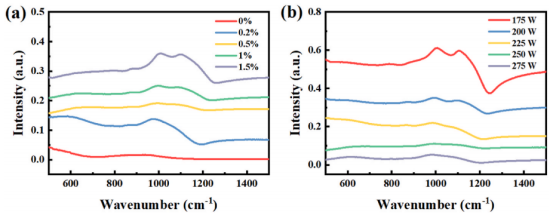
(a) A组和(b) B组SiOₓ薄膜的FTIR光谱
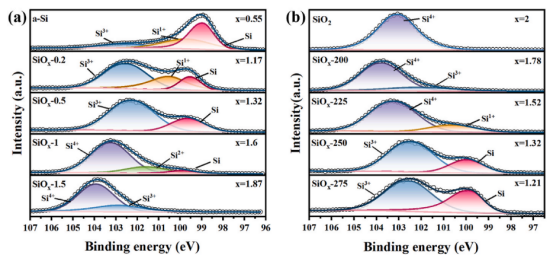
(a) A组和(b) B组SiOₓ薄膜的Si 2p XPS光谱
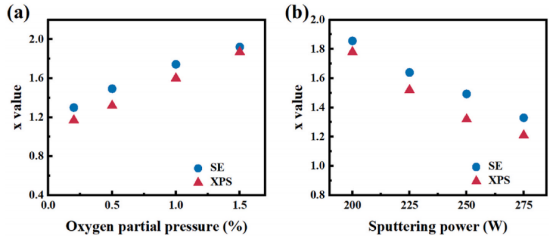
(a) A组和(b) B组SiOₓ薄膜通过SE与XPS计算的x值对比
通过BEMA模型获得的SiOₓ中SiO₂体积分数可换算为化学计量比x(x = 2×V SiO₂)。FTIR光谱显示,随氧分压增加,Si-O-Si伸缩振动峰增强并向高波数移动,证实氧化程度提高。XPS定量分析进一步揭示了Si的不同氧化态(Si⁰至Si⁴⁺)分布随工艺参数的变化。由SE-BEMA与XPS独立测得的x值高度吻合(最大偏差约0.17),充分证明了椭偏光学模型在定量分析薄膜化学组成方面的能力与精度。
本研究成功构建了一套基于Tauc-Lorentz与BEMA模型的光谱椭偏分析框架,实现了对磁控溅射SiOₓ薄膜厚度、光学常数及化学组成的快速、无损、精准表征。研究明确了氧分压与溅射功率对薄膜组成、结构与光学性质的调控规律:低氧分压与高溅射功率有利于形成富硅、高折射率SiOₓ;反之则获得更接近SiO₂、低折射率的薄膜。该工作凸显了光谱椭偏仪结合物理光学模型,在功能薄膜研制与工艺监控中作为强大原位分析工具的潜力,为其在更广泛的非化学计量薄膜体系中的应用提供了方法学示范。

技术支持:180-1566-6117
费曼仪器全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)。
▶先进的旋转补偿器测量技术:无测量死角问题。
▶粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
▶秒级的全光谱测量速度:全光谱测量典型5-10秒。
▶原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm费曼仪器全光谱椭偏仪能非破坏、非接触地原位精确测量超薄图案化薄膜的厚度、折射率,结合费曼仪器全流程薄膜测量技术,助力半导体薄膜材料领域的高质量发展。
原文参考:《Optical modeling of SiOx thin films for physicochemical property measurement by spectroscopic ellipsometry》