基于光谱椭偏法的二维TMDs材料光学常数表征综述
二维过渡金属二硫化物(TMDs)具有原子级厚度、可调带隙结构等优异特性,被认为是延续摩尔定律向极限制程发展的重要候选材料。然而,在将二维TMDs集成到未来半导体器件之前,还需解决大面积生长和有效掺杂等关键挑战。此外,对TMDs纳米尺度光学行为的精准分析和二维半导体器件设计,都依赖于材料光学常数的精确获取,但目前相关数据仍然稀缺。
本文采用光谱椭偏法表征了单层MoS₂及不同掺杂浓度的Fe-MoS₂的光学常数,为二维半导体沟道材料的光子学应用提供新的实验和理论数据支持。Flexfilm费曼仪器全光谱椭偏仪可以非接触对薄膜的厚度与折射率的高精度表征,广泛应用于薄膜材料、半导体和表面科学等领域。
样品制备与光学模型

二维MoS₂样品与拉曼表征
本研究通过Fe辅助化学气相沉积(CVD)在c面蓝宝石衬底上合成了单层MoS₂样品。为了评估薄膜厚度均匀性,对掺有Fe的单层MoS₂进行了横向(X方向)和纵向(Z方向)的拉曼光谱线扫描。结果表明,在两个方向上拉曼峰位置几乎一致,说明薄膜厚度高度均匀。

c-Al2O3基底二维 MoS2光学模型
在光学表征前,需要建立相应的色散模型。对于该样品,可将其简化为由空气层、单层MoS₂层、过渡层和蓝宝石衬底组成的四层结构。其中蓝宝石衬底为透明材料,为避免衬底表面粗糙度影响,在其上引入一个过渡层,将过渡层视为50% MoS₂与50%空气混合的等效介质。该层次结构的引入有助于提高后续拟合的准确性。
对于光学色散方程的选择,蓝宝石衬底色散采用Cauchy方程来描述;而单层MoS₂层的介电响应则用含四个振子的Tauc-Lorentz色散模型来表征。该模型由Jellison和Modine基于Tauc态密度联合Lorentz振子原理提出,在该模型中,主要参数包括光学带隙Eg、振子中心能E₀、强度A、展宽项C等,它们满足一定的物理关系,可通过拟合实验椭偏数据提取。
椭偏测试与光学常数分析

二维TMDs的Tauc-Lorentz色散方程的参数结果
采用Flexfilm全光谱椭偏仪对样品进行测试(入射角70°,波长范围310~1000 nm)。通过在生长过程中加入不同比例的FeCl₂粉末,制备了未掺杂的本征MoS₂样品以及掺入1 mg和5 mg FeCl₂粉末的Fe-MoS₂样品。需要指出的是,当FeCl₂用量增加到5 mg时,样品中的Fe掺杂含量已接近饱和。利用所建立的光学模型对椭偏测量光谱进行拟合,提取出Tauc-Lorentz色散方程的14个参数。结果显示各样品的光谱拟合效果良好,验证了所建模型和选用色散方程的有效性。
参数结果显示,掺杂对MoS₂光学特性产生显著影响。例如,本征单层MoS₂的光学带隙Eg约为1.604 eV,掺1 mg和5 mg FeCl₂时分别变化为2.132 eV和1.965 eV。同时,随着掺杂浓度的增加,多个振子吸收峰的强度(参数A₂、A₃、A₄等)明显增大,表明掺杂强化了相应能带跃迁的吸收特性。此外,表中给出的拟合误差eRMS均处于较低水平,进一步说明拟合的可靠性。
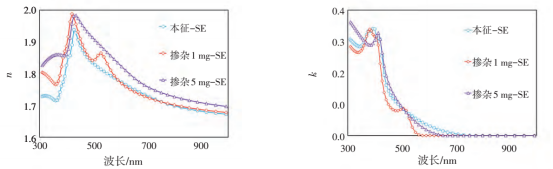
二维TMDs的光学常数:(左)折射率实部n(右)折射率虚部k
基于拟合得到的Tauc-Lorentz模型参数,可以计算出材料的介电常数,并由此导出折射率实部n和虚部k,在可见光波段(310~500 nm)内,掺杂浓度对n和k的影响尤为显著,这意味着可以通过光学常数的变化高灵敏地区分不同掺杂水平的样品。在紫外波段,所有样品均表现出较高的折射率,而且随着掺杂浓度的提高折射率进一步增大。值得注意的是,在700~1000 nm近红外区域,所有样品的k值接近于零,表明此波段内材料的光吸收可忽略不计,为TMDs在低损耗纳米光子学领域的应用提供了可能。
本文制备并表征了本征单层MoS₂及不同Fe掺杂浓度的MoS₂薄膜,并在c-Al₂O₃衬底上构建了包含过渡层的三层光学模型。在该模型中,蓝宝石衬底采用Cauchy方程描述,MoS₂层采用四振子Tauc-Lorentz色散模型。椭偏实验与理论光谱拟合结果一致良好,验证了模型和色散方程的有效性。利用光谱椭偏法提取出的模型参数进一步用于计算310~1000 nm波段内各样品的折射率和吸收系数,为二维TMDs材料的光学特性研究及其在半导体沟道器件和光子学中的设计与应用提供了实验和计算依据。
Flexfilm费曼仪器全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)。
▶先进的旋转补偿器测量技术:无测量死角问题。
▶粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
▶秒级的全光谱测量速度:全光谱测量典型5-10秒。
▶原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm全光谱椭偏仪能非破坏、非接触地原位精确测量超薄图案化薄膜的厚度、折射率,结合费曼仪器全流程薄膜测量技术,助力半导体薄膜材料领域的高质量发展。
原文参考:《基于光谱椭偏法的二维过渡金属二硫化物光学常数表征》