SU-8光刻胶的光学特性研究:190-1680 nm波段的光谱椭偏分析
SU-8是一种在微纳加工领域应用广泛的环氧基负性光刻胶,因其能够制备高深宽比微结构而备受关注,在微机电系统、光波导和生物医学器件等领域具有重要价值。准确掌握其光学常数(折射率n和消光系数k)对于器件设计与工艺优化至关重要。然而,现有研究多集中于有限波段(300-800 nm),且缺乏系统的测量与建模,难以满足宽光谱应用的需求。Flexfilm费曼仪器全光谱椭偏仪可以非接触对薄膜的厚度与折射率的高精度表征,广泛应用于薄膜材料、半导体和表面科学等领域。
本研究采用光谱椭偏技术,结合反射与透射测量模式,在190-1680 nm宽波段范围内对SU-8的光学函数进行了系统表征。通过B样条、四高斯振荡器和Cody-Lorentz三种模型对实验数据进行拟合与比较,并结合含时密度泛函理论计算从分子层面验证吸收机制,最终建立了SU-8完整的光学函数模型,为其在光电器件和微细加工领域的应用提供了可靠的数据支撑。
椭偏术原理
光谱椭偏是一种利用偏振光反射来表征薄膜的光学技术。通过适当的建模,椭偏数据可以提供薄膜厚度、粗糙度、组分浓度比以及薄膜的光学函数(即折射率n和消光系数k)。椭偏是一种理想的 analytical 技术,因为它通常快速、非破坏性,可在环境条件下进行,并且能够实现对样品的实时原位监测。
SU-8光刻胶

四聚体SU-8单体/低聚物及其在光酸发生剂和紫外光存在下发生的聚合反应
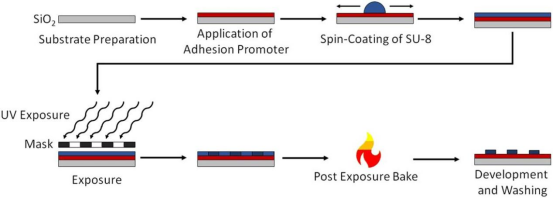
标准SU-8薄膜加工工艺流程
SU-8是一种基于环氧树脂的高分辨率负性光刻胶,能够形成具有垂直侧壁的高深宽比结构,厚度可达500至750微米。其名称源于“SU”(代表“紫外结构化”)和“8”(代表其单体/低聚物中平均拥有的八个环氧基团)。SU-8通常以单体/低聚物和光酸发生器(如三芳基锍盐)溶解于有机溶剂(如γ-丁内酯或环戊酮)中的溶液形式存在。在紫外光曝光下,光酸发生器诱导阳离子光聚合,使环氧基团交联。随后的曝光后烘焙加热过程会增强交联并再生酸催化剂,从而显著提高光刻胶的灵敏度,并使其具备高机械强度和热稳定性。
交联后的SU-8薄膜对酸、碱和溶剂具有良好的耐受性,因此在众多领域中得到应用,包括单模和多模聚合物光波导、微透镜、干涉仪、衍射光栅以及光遗传学探针等。由于其良好的透光性、相对较高的折射率以及聚合后约7.5%的低收缩率,SU-8在光电子学领域具有重要价值。此外,与硅基材料相比,SU-8具有更高的柔韧性(比模量约4.02 GPa),因此特别适用于微机械表面应力传感器、惯性传感器、谐振器以及悬臂梁式传感器等。例如,固化后的SU-8悬臂梁提高了原子力显微镜的成像速度。在微技术领域,SU-8也被用于制造具有超顺磁性的微型机器人。未固化的SU-8则可作为有效的牺牲层用于表面微加工。基于SU-8的微机电系统因其生物相容性和电学性能而被广泛应用于生物医学领域,例如药物输送容器、神经探针、涂层电极以及适用于微流控和纳流控的嵌入式微通道。因此,理解和模拟SU-8的光学函数对于其微加工工艺和应用都至关重要。
实验方法
样品制备
为消除基底背反射对椭偏信号的干扰,本研究采用硅片粗糙面及粗糙化玻璃作为沉积基底。基底经食人鱼溶液清洗、去离子水漂洗后进行脱水烘焙(200°C, 10 min)。随后旋涂增粘剂OmniCoat™(3000 rpm, 30 s)并软烘焙(200°C, 1 min)。SU-8 2025光刻胶以约4 mL的用量旋涂于基底表面,通过阶梯转速控制(500 rpm, 6 s → 4000 rpm, 30 s → 6000 rpm, 2 s)获得约25 μm厚的均匀薄膜。涂胶后依次进行软烘焙(65°C, 1 min → 95°C, 5 min)以去除溶剂。
紫外曝光采用365 nm波长光源,曝光剂量为8.8 mW/cm²,均匀照射整个样品表面(无掩模图案)。曝光后进行后烘(65°C, 1 min → 95°C, 5 min → 65°C, 1 min)以促进交联反应,最后经硬烘焙(150°C, 5 min)完成固化。
椭偏测量与数据分析
采用Flexfilm全光谱椭偏仪进行数据采集。反射模式测量在52°、57°和62°三个入射角下进行,透射模式测量则将样品置于光源与检测器之间(光路垂直于样品表面)。所有数据均使用CompleteEASE软件进行建模分析。
为监测SU-8在固化过程中的光学变化,进行了4小时的原位反射测量(入射角75°,采样间隔2.6 s)。数据按时间均分为20段,每段数据平均后采用四高斯振荡器模型进行拟合。
量子化学计算

使用CREST和xTB方法定位的SU-8单体模型三维结构
采用CAM-B3LYP/6-31G**方法进行含时密度泛函理论计算,模拟SU-8单体的紫外-可见吸收光谱。通过PM6半经验方法和CREST/xTB紧束缚方法进行构象搜索,获得两个稳定的单体结构用于激发态计算。
结果与讨论
光学模型的建立与比较
本研究采用三种不同策略对SU-8的光学函数进行建模:
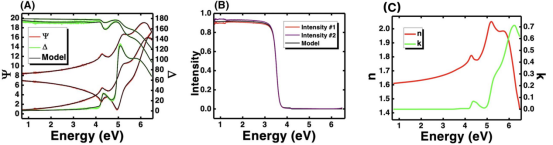
B样条模型拟合:(A)反射椭偏Ψ和Δ光谱(B)透射光谱(C) SU-8光学函数
B样条模型:采用自适应节点分布(高能区节点间距0.1 eV,低能区0.3 eV),强制满足Kramers-Kronig关系。该模型拟合效果最佳,MSE值仅为1.52。由此获得的光学函数显示SU-8在λ > 400 nm波段完全透明(k ≈ 0),折射率呈现正常色散;短波区域出现明显的吸收峰和折射率异常色散。

四高斯振荡器模型拟合:(A)反射椭偏Ψ和Δ光谱(B)透射光谱(C) SU-8光学函数
四高斯振荡器模型:包含四个高斯振荡器描述主要吸收特征(位于约6.1、5.3、4.4和3.8 eV处),并引入紫外极点(11.7 eV)和红外极点(振幅设为零)以考虑测量范围外的吸收贡献。MSE值为2.146。
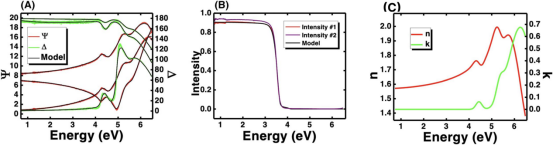
Cody-Lorentz模型拟合:(A)反射椭偏Ψ和Δ光谱(B)透射光谱(C) SU-8光学函数
Cody-Lorentz模型:结合Cody-Lorentz带隙振荡器和三个高斯振荡器,描述从带边到高能区域的完整吸收谱。带隙参数拟合为3.378 eV,与文献报道的SU-8吸收边位置(350-360 nm)高度一致。MSE值为2.232。
所有模型均引入基于Bruggeman有效介质近似的表面粗糙层(50% SU-8 + 50%空隙),使拟合优度提升25%以上,表明表面形貌对椭偏测量具有不可忽视的影响。
原位固化过程监测

4小时内采集的原位数据均匀分为20个部分,经平均后拟合:(A)全部20个部分的Ψ和Δ光谱叠加图;(B)全部20个部分的光学常数叠加图
对未显影SU-8在环境光下的固化过程进行4小时连续监测。20个时间段平均数据的拟合结果表明,无论是椭偏参数(Ψ, Δ)还是提取的光学函数(n, k),在整个过程中均未发生可检测的变化。这一结果证实聚合反应主要涉及环氧基团的开环交联,而作为主要生色团的芳环结构未受影响,因此光学性质保持稳定。
理论计算与实验结果的对比

两种SU-8单体模型的CAM-B3LYP/6-31G** TD-DFT激发结果
TD-DFT计算预测SU-8单体的主要电子跃迁为π→π*跃迁(具有电荷转移特性),激发能位于5.9-6.1 eV区间,振荡强度分别为0.48和0.66。这一结果与实验测得的6.1 eV附近强吸收峰高度吻合。然而,计算未能复现4.5 eV处的实验吸收峰,该特征可能来源于SU-8配方中的光酸发生剂或其他添加剂成分。
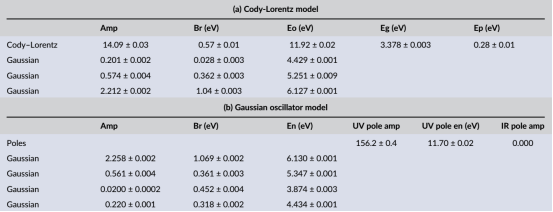
本研究中使用的两种基于振荡器的模型参数:(a)带有三个高斯振荡器的Cody-Lorentz模型和(b)四高斯振荡器模型
本研究利用三种不同模型对SU-8光刻胶进行了详细的光谱椭偏分析,并由此确定了材料的光学函数。其中,B样条模型获得了最低的MSE值。然而,四高斯模型在时间研究的原位数据分析中表现更佳。该原位分析未显示光刻胶在显影过程中的光学性质有任何变化。TD-DFT计算预测的吸收峰(主要来自光刻胶中的芳基)与椭偏实验结果一致。

技术支持:180-1566-6117
Flexfilm费曼仪器全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)。
▶先进的旋转补偿器测量技术:无测量死角问题。
▶粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
▶秒级的全光谱测量速度:全光谱测量典型5-10秒。
▶原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm全光谱椭偏仪能非破坏、非接触地原位精确测量超薄图案化薄膜的厚度、折射率,结合费曼仪器全流程薄膜测量技术,助力半导体薄膜材料领域的高质量发展。
原文参考:《Spectroscopic ellipsometry of SU-8 photoresist from 190 to 1680 nm (0.740–6.50 eV)》