AlN薄膜表征难点解析:椭偏仪从光学常数到附着性能的系统表征
氮化铝(AlN)作为Al-N二元体系中唯一的稳定相,具有六方纤锌矿结构,是一种宽带隙半导体材料,禁带宽度达6.2 eV。其具备高电阻率、低热膨胀系数、高硬度、良好的化学稳定性以及优异的热导率(3.2 W/cm·K),在可见光至红外波段也表现出较高的光学透过率。这些特性使AlN薄膜在微电子器件、光电器件以及防护涂层等领域具有广泛的应用前景。Flexfilm费曼仪器全光谱椭偏仪可以非接触对薄膜的厚度与折射率的高精度表征,广泛应用于薄膜材料、半导体和表面科学等领域。
制备AlN薄膜的方法包括化学气相沉积(CVD)、分子束外延(MBE)、反应磁控溅射、脉冲激光沉积、离子注入以及真空磁过滤电弧离子镀等。本文采用真空磁过滤电弧离子镀法在单晶Si(100)基片上制备AlN薄膜,利用椭偏法测量其光学常数,并围绕膜基附着方式及薄膜折射率低于块体材料的原因展开分析。
实验方法
薄膜制备在等离子体镀膜设备上完成,靶材为纯铝靶,基片为双面抛光的单晶Si(100)薄片,尺寸为15 mm × 15 mm。基片在装入真空室前经醇醚混合液与超声波清洗。镀膜前将沉积室真空度抽至4.9 × 10⁻³ Pa,通入氩气(Ar)后开启霍尔离子源对基片进行溅射清洗;镀膜时关闭Ar,通入纯度为99.99%的氮气(N₂)并引燃电弧,使沉积室处于等离子体状态。
电弧离子镀具有高离化率的特点,等离子体中含有大量带电粒子(如Ar⁺、N⁺、N₂⁺等),在磁场和基体负偏压作用下,正离子加速轰击基体表面,促进氮与铝反应,最终在基体表面沉积形成AlN薄膜。主要工艺参数为:工作气压1.3 × 10⁻¹ Pa,靶电流75 A,基底偏压-50 V,沉积时间5分钟。
椭偏仪测量原理
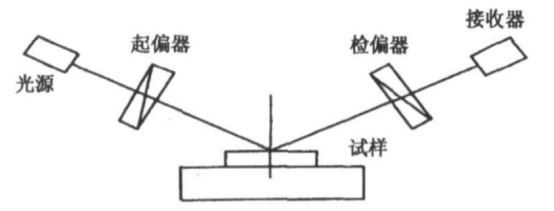
椭偏仪测量原理简图
采用Flexfilm费曼仪器全光谱椭偏仪进行薄膜光学常数测量。系统由光源、起偏器、接收器和计算机等构成。光源发出的光经起偏器后成为线偏振光,入射至样品表面。由于P分量(平行于入射面)与S分量(垂直于入射面)在反射过程中的反射率与透射率存在差异,反射光转变为椭圆偏振光。通过测量位相差Δ和振幅比反正切ψ,即可反推得到薄膜的折射率、消光系数及厚度等参数。
膜系建立与拟合

模型1

模型2
根据直流电弧离子镀的沉积特点,结合薄膜与基片之间的附着方式,建立了两种膜系模型进行拟合分析。
模型1(简单附着):膜系结构为Si / SiO₂ / AlN薄膜(柯西模型) / 粗糙层(Srough)。其中SiO₂为硅基底表面的自然氧化层,AlN薄膜采用柯西模型拟合(适用于弱吸收介质),粗糙层的有效介电常数通过有效介质理论模拟。
模型2(扩散附着):膜系结构为Si / 有效介质层(Si与AlN混合层) / AlN薄膜(柯西模型) / 粗糙层。该模型假设沉积过程中高能离子使薄膜成分渗入基底表层,形成“伪扩散层”,其介电常数由Bruggeman有效介质理论描述。
拟合过程中以实测值为基准,通过调整膜层厚度和色散系数,使理论计算曲线与实际测量曲线逼近,评价标准为均方根误差(MSE)最小化。
测试结果与分析
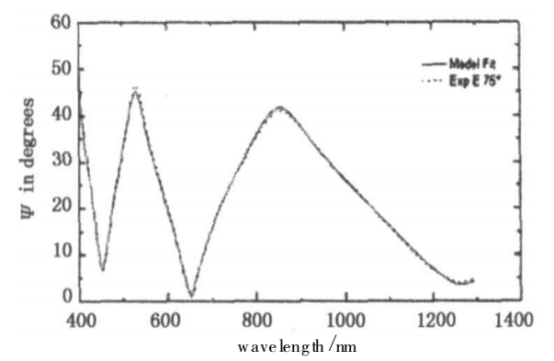
拟合曲线
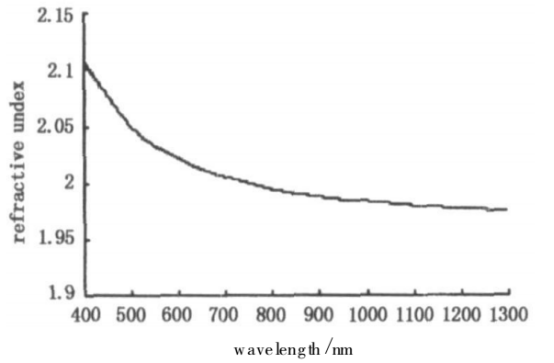
折射率变化趋势
两种模型的拟合结果如下:
模型1:MSE为7.73,膜厚361 nm,粗糙层厚度3.94 nm,在632.8 nm波长下折射率约为2.015,消光系数为0。
模型2:MSE为13.83,膜厚367.5 nm,折射率约为2.012,消光系数为0。
模型1的MSE值更小,拟合效果更优,表明在本实验工艺条件下,AlN薄膜与硅基片之间为简单附着,未形成明显的扩散混合层。模型1拟合得到的折射率在可见光至近红外波段(632.8 nm附近)介于1.988至2.109之间,消光系数在整个测量波段均为0,验证了AlN薄膜在该波段为透明膜。
膜基附着方式
根据电子显微分析,薄膜附着方式可分为简单附着、扩散附着、中间层附着及宏观效应附着等。模型1对应简单附着,即薄膜与基体之间存在清晰分界面,薄膜均匀覆盖于SiO₂层表面,未渗入硅基底;模型2对应扩散附着,表现为薄膜与基体之间形成混合层。拟合结果表明模型1更符合本实验条件,说明膜基之间为简单附着。
折射率低于块体材料的原因
块体AlN材料的折射率约为2.15,而本研究中薄膜折射率略低,主要原因有三:
沉积温度较低:实验在室温下进行,未对基片加热,且靶电流与基底偏压较小,离子能量不足,基片温度保持较低水平,导致残余气体分子难以排出,在膜层中形成空隙,降低了折射率;
成分偏离化学计量比:AlN薄膜中Al与N的比例未能严格达到1:1,成分偏差影响折射率;
表面氧化:沉积完成后,薄膜表面与空气接触,氧取代部分氮形成Al₂O₃钝化层,其折射率低于AlN,进一步拉低了整体薄膜的折射率。
通过椭偏法分析并结合沉积工艺特点,建立了适用于氮化铝薄膜的膜系结构,拟合结果显示在632.8 nm波长下薄膜折射率约为2.015、消光系数为0,在可见光至近红外波段折射率介于1.988至2.109之间;在本实验工艺条件下,薄膜与硅基片之间为简单附着,未形成扩散混合层,而薄膜折射率低于块体材料(2.15)的主要原因包括膜层中存在空隙、Al/N成分偏离化学计量比以及表面形成Al₂O₃钝化层。
Flexfilm费曼仪器全光谱椭偏仪

技术支持:180-1566-6117
Flexfilm费曼仪器全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)。
▶先进的旋转补偿器测量技术:无测量死角问题。
▶粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
▶秒级的全光谱测量速度:全光谱测量典型5-10秒。
▶原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm费曼仪器全光谱椭偏仪能非破坏、非接触地原位精确测量超薄图案化薄膜的厚度、折射率,结合费曼仪器全流程薄膜测量技术,助力半导体薄膜材料领域的高质量发展。
原文参考:《氮化铝薄膜的椭偏法研究》