台阶仪在光刻胶膜厚测量中的应用|AZ4620厚胶工艺详解
微机电系统(MEMS)器件因其小型化、集成化及低成本优势,被广泛应用于消费电子、工业及汽车领域,其中压力传感器对刻蚀结构的几何精度要求尤为严格。研究表明,刻蚀侧壁的垂直度直接影响器件的力学响应一致性与电学输出稳定性。Flexfilm费曼仪器探针式台阶仪可以实现表面微观特征的精准表征与关键参数的定量测量,精确测定样品的表面台阶高度与膜厚,为材料质量把控和生产效率提升提供数据支撑。
在压力传感器背腔结构加工过程中,若光刻胶掩膜侧壁倾角偏离90°,将导致刻蚀过程中掩膜顶部优先损耗,进而引起硅背腔侧壁倾角偏差。这种偏差不仅改变腔体体积,还削弱膜片边界的固支条件,使应力分布失真,最终降低惠斯通电桥输出信号,影响传感器精度。
因此,相较于传统仅优化刻蚀参数的方法,本文从光刻胶掩膜本身的侧壁形貌控制出发,系统研究匀胶转速、曝光剂量及后烘条件对侧壁倾角的影响,以实现高垂直度掩膜结构。
实验方法
光刻胶材料选择
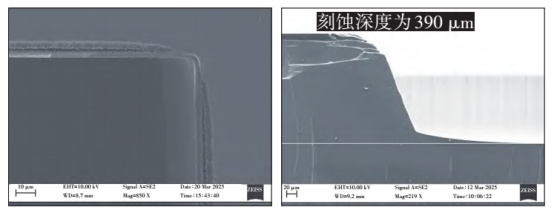
背腔侧壁倾角偏离图
常见厚胶材料包括AZ4620、AZ6130及RDP-2100P。其中:
AZ4620:高黏度、高抗刻蚀性,刻蚀选择比可达108:1,可支持500 μm深刻蚀
AZ6130:膜厚较薄,选择比不足,难以满足深硅刻蚀
RDP-2100P:刻蚀深度受限,需引入硬掩模,工艺复杂
综合考虑,选用AZ4620光刻胶作为背腔刻蚀掩膜材料。
工艺流程
采用4英寸<100>硅片,完整光刻流程包括:
HMDS增粘处理
匀胶(旋涂)
前烘(110 ℃,3 min)
接触式曝光
显影
等离子去胶
后烘
其中,HMDS用于增强光刻胶与硅基底的附着力,抑制显影及刻蚀过程中的侧向腐蚀问题。
匀胶转速对膜厚的影响(台阶仪关键应用)
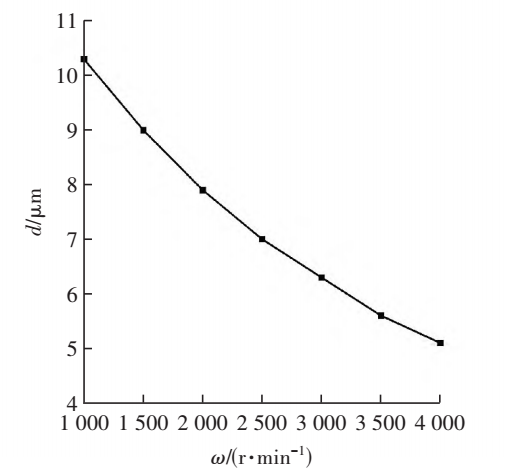
d与ω的关系
光刻胶膜厚d与匀胶转速ω满足幂律关系:d∝ω−α
在实际工艺中,考虑390 μm深刻蚀及安全冗余,目标光刻胶厚度约为7.2 μm。
以2500 r/min为中心设置转速梯度实验,并引入Flexfilm探针式台阶仪进行膜厚测量。该方法通过机械接触扫描实现纳米级高度分辨率,能够直接获取:
· 光刻胶实际厚度
· 台阶高度均匀性
· 匀胶稳定性
实验结果表明:
转速从1000 r/min提升至4000 r/min时,膜厚由10.3 μm降至5.2 μm
膜厚与转速呈显著负相关
在2500 r/min时,膜厚约为7 μm,与理论值偏差小于3%
关键结论:
台阶仪在该阶段不仅用于厚度标定,还用于验证理论模型与实际工艺的一致性,是匀胶参数优化的核心计量手段。
曝光剂量对显影质量的影响
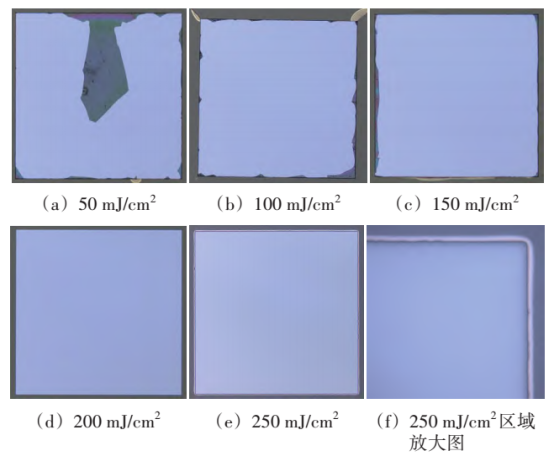
不同曝光剂量下的显影图
曝光剂量直接决定光刻胶光化学反应程度:
剂量不足(50–150 mJ/cm²):底部曝光不充分,残胶严重,显影不完全
最优剂量(200 mJ/cm²):图形完整、无残胶、无过显
剂量过高(250 mJ/cm²):边缘粗糙,出现轻微过曝光效应
因此确定最佳曝光剂量为200 mJ/cm²。
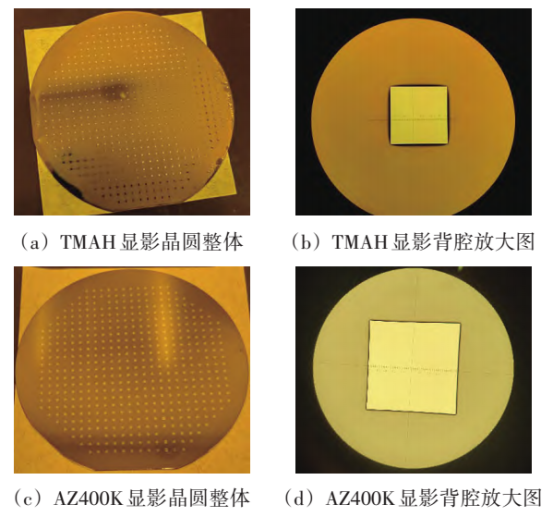
AZ4620光刻胶经TMAH和 AZ400K效果对比
显影液对比
对比两种显影体系:
TMAH:显影活性强,但存在“白雾”起胶缺陷(隐性过显)
AZ400K(1:3稀释):图形完整,无表面缺陷
最终选用AZ400K显影体系。
后烘工艺对侧壁倾角的影响

2500 r/min匀胶转速时不同后烘温度和时间下光刻胶掩膜侧壁倾角SEM截面形貌图
显影后光刻胶仍含有溶剂(PGMEA及水分),结构松散。后烘通过:
溶剂挥发
酚醛树脂交联
内应力释放
实现掩膜致密化与形貌稳定
实验结果分析
在2500 r/min条件下,不同后烘参数对侧壁倾角(θ)的影响如下:

规律总结:
高温 → 光刻胶进入黏弹流动区 → 侧壁塌陷
中温 → 溶剂挥发与热回流耦合 → 倾角缓慢改善
低温(70℃) → 形貌保持稳定 → 实现垂直侧壁
最优条件:70℃,10 min
刻蚀结果验证

背腔刻蚀侧壁倾角与形貌图
采用优化后的光刻胶掩膜进行深硅刻蚀(390 μm),得到:
掩膜侧壁倾角:90°
背腔刻蚀侧壁倾角:90.2°
结果表明,光刻胶掩膜的垂直度能够有效传递至硅刻蚀结构,实现高保真图形转移。
本文围绕AZ4620光刻胶在MEMS压力传感器背腔刻蚀中的应用,对匀胶转速、曝光剂量及后烘工艺进行了系统优化,并通过Flexfilm探针式台阶仪实现膜厚的精确测量与工艺闭环控制:在2500 r/min条件下获得约7 μm目标膜厚,结合200 mJ/cm²曝光剂量与AZ400K显影体系,并采用70℃、10 min后烘工艺,成功制备出侧壁倾角为90°的垂直光刻胶掩膜;进一步经390 μm深硅刻蚀后,背腔侧壁倾角达到90.2°,实现高保真结构转移。结果表明,该工艺有效解决了掩膜侧壁倾角引发的刻蚀偏差问题,同时验证了台阶仪在厚胶膜厚控制与工艺窗口优化中的关键计量作用。

技术支持:180-1566-6117
在半导体、光伏、LED、MEMS器件、材料等领域,表面台阶高度、膜厚的准确测量具有十分重要的价值,尤其是台阶高度是一个重要的参数,对各种薄膜台阶参数的精确、快速测定和控制,是保证材料质量、提高生产效率的重要手段。
✔ 配备500W像素高分辨率彩色摄像机
✔ 亚埃级分辨率,台阶高度重复性1nm
✔ 360°旋转θ平台结合Z轴升降平台
✔ 超微力恒力传感器保证无接触损伤精准测量
费曼仪器作为国内领先的薄膜厚度测量技术解决方案提供商,Flexfilm探针式台阶仪可以对薄膜表面台阶高度、膜厚进行准确测量,保证材料质量、提高生产效率。
原文参考:《基于AZ4620光刻胶的垂直掩膜工艺参数优化》