台阶仪在薄膜晶体管的应用 | 精准表征有源层厚度均匀性
在薄膜晶体管(TFT)的研发与性能优化中,有源层(即半导体沟道层)的厚度是决定器件电学特性(如阈值电压、开关比、迁移率)的核心参数之一。本文聚焦于互补型薄膜晶体管(CTFT)的工艺优化,系统探究了P型SnO、Te及N型SnO₂薄膜的厚度对最终器件性能的影响。为确保实验结论的可靠性,精确控制并验证薄膜的实际沉积厚度成为前提条件。
本研究采用Flexfilm费曼仪器探针式台阶仪,对上述三种经不同工艺制备的薄膜进行了非破坏性的厚度表征,其核心作用在于精准表征有源层厚度均匀性,为后续建立“工艺-结构-性能”关联机制提供了关键的定量数据支撑,确保了优化实验的有效性与可重复性。
实验与方法
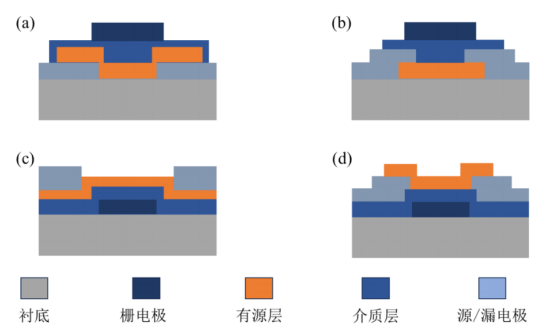
薄膜晶体管的四种基本结构示意图(a)顶栅顶接触(b)顶栅底接触(c)底栅顶接触(d)底栅底接触
为确保不同批次、不同材料薄膜厚度的精确性与一致性,本研究使用Flexfilm探针式台阶仪对所有关键有源层进行厚度标定。
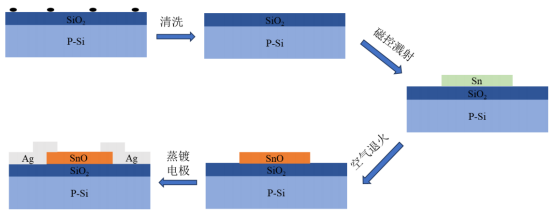
SnO TFT制备工艺流程图
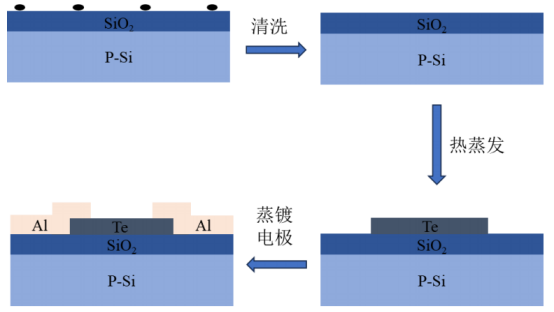
Te TFT制备工艺流程图
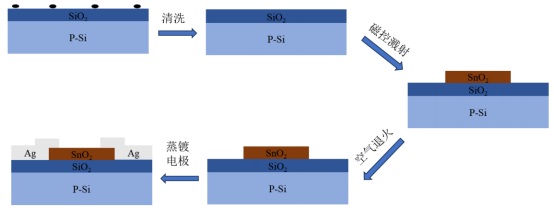
SnO₂ TFT制备工艺流程图
仪器与应用:台阶仪被用于测量SnO、Te及SnO₂三种薄膜的物理厚度,验证磁控溅射和热蒸发等沉积工艺的稳定性。
样品制备与测试流程:在硅基底上完成薄膜沉积后,无需特殊前处理,直接使用台阶仪进行测量。为避免局部不均匀性带来的误差,对每片样品均选取5个不同区域进行多点扫描,记录并计算厚度平均值与偏差。
误差控制:
对于较薄的SnO和Te薄膜(目标厚度5-35 nm),测试结果表明厚度偏差被严格控制在±1.5 nm,相对误差小于 10%。
对于稍厚的SnO₂薄膜(目标厚度10-30 nm),厚度偏差同样控制在 ±3 nm 以内。这种严格的误差控制策略,排除了因厚度不均对器件性能造成干扰的可能性,使后续性能变化可归因于退火温度、时间等独立变量。
有源层厚度对SnO TFT性能的影响
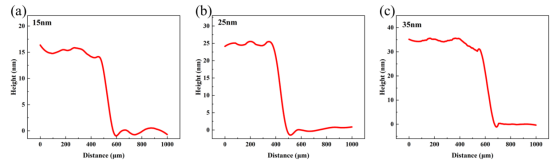
SnO薄膜厚度测量图(a)15 nm(b)25 nm(c)35 nm
台阶仪精确标定了三种SnO有源层厚度:15 nm、25 nm和35 nm。实验结果显示,当厚度为25 nm时,SnO TFT展现出最佳的P型导电性能(开关比 1.98×103,迁移率 0.506 cm2/(V⋅s))。台阶仪提供的厚度数据是解释这一现象的关键:15 nm的薄膜过薄,其电性能易受表面缺陷(如氧空位)的显著影响,导致陷阱态密度增加,迁移率下降;而35 nm的薄膜在空气退火氧化时,底部氧化不充分,残留未反应的金属Sn,导致双极导通特性,使开关比降至 102。台阶仪的测量结果证实,只有25 nm的薄膜在氧化深度(形成足够的SnO相)与抑制表面缺陷之间达到了最佳平衡。
有源层厚度对Te TFT性能的影响
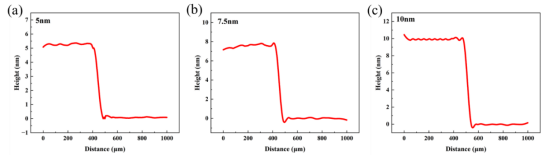
Te薄膜厚度测量图(a)5 nm(b)7.5 nm(c)10 nm
台阶仪精确验证了5 nm、7.5 nm和10 nm的Te薄膜厚度。电学测试表明,5 nm厚的Te TFT性能最佳(开关比 6.4×103,迁移率 2.34 cm2/(V⋅s))。台阶仪的厚度数据直接支撑了对这一现象的物理解释:当Te薄膜厚度从10 nm减小至5 nm时,量子限制效应显著增强,有效带隙增大,从而有效抑制了关态电流,提升了开关比。台阶仪的精确测量使得这种微观物理效应在宏观器件性能上的体现得到了量化验证。
有源层厚度对SnO₂ TFT性能的影响
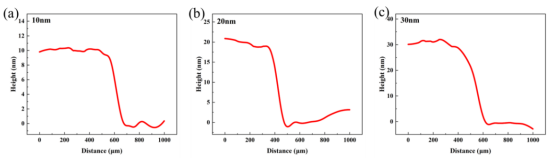
SnO₂薄膜厚度测量图(a)5 nm(b)7.5 nm(c)10 nm
台阶仪对不同沉积时间的SnO₂薄膜进行了标定,确认了10 nm、20 nm和30 nm的厚度系列。实验发现,当厚度从10 nm增加至20 nm时,迁移率从 0.556 cm2/(V⋅s)提升至 1.33 cm2/(V⋅s)。台阶仪的数据表明,20 nm的厚度有效减少了载流子输运路径上的表面散射(10 nm时显著),从而提升了迁移率。然而,当厚度增至30 nm时,尽管迁移率继续上升,但栅极对沟道的控制能力减弱,导致亚阈值摆幅从4.52 V/dec劣化至 7.09 V/dec,开关比下降。台阶仪的精确厚度测量,为这种“栅控效率”与“载流子输运”之间的权衡提供了量化依据。
本研究采用台阶仪对SnO、Te、SnO₂三种薄膜晶体管的有源层厚度进行了精确的多点测量,将厚度偏差控制在极小的范围内(±1.5 nm),为探究工艺参数与器件性能之间的内在联系提供了坚实的数据基础。台阶仪的测量结果直接揭示了有源层厚度如何通过影响氧化程度、量子限制效应及栅控能力,来调控TFT的关键电学参数。
Flexfilm探针式台阶仪

技术支持:180-1566-6117
在半导体、光伏、LED、MEMS器件、材料等领域,表面台阶高度、膜厚的准确测量具有十分重要的价值,尤其是台阶高度是一个重要的参数,对各种薄膜台阶参数的精确、快速测定和控制,是保证材料质量、提高生产效率的重要手段。
✔ 配备500W像素高分辨率彩色摄像机
✔ 亚埃级分辨率,台阶高度重复性1nm
✔ 360°旋转θ平台结合Z轴升降平台
✔ 超微力恒力传感器保证无接触损伤精准测量
费曼仪器作为国内领先的薄膜厚度测量技术解决方案提供商,Flexfilm探针式台阶仪可以对薄膜表面台阶高度、膜厚进行准确测量,保证材料质量、提高生产效率。
原文参考:《互补型薄膜晶体管工艺及性能优化技术探究》