台阶仪在磁性薄膜的应用 | 纳米级厚度量化交换偏置场
在自旋电子学器件制造领域,FeMn/CoFeB薄膜体系因其优异的交换偏置特性,已成为磁随机存取存储器(MRAM)和磁传感器研究中的核心结构之一。交换偏置效应源于反铁磁(AFM)层与铁磁(FM)层在界面处的耦合作用,其强弱直接决定器件的磁稳定性与信号响应灵敏度。Flexfilm费曼仪器探针式台阶仪可以实现表面微观特征的精准表征与关键参数的定量测量,精确测定样品的表面台阶高度与膜厚,为材料质量把控和生产效率提升提供数据支撑。
然而,这一效应对薄膜厚度极为敏感:FeMn 层厚度偏差数纳米便可导致交换偏置场从数百 Oe 骤降至零,CoFeB 铁磁层厚度的微小变化同样会显著改变界面耦合强度。因此,在纳米量级薄膜体系的研究中,实现对各功能层厚度的精准测量与控制,是获得稳定交换偏置效应的前提条件。台阶仪(触针式轮廓仪)凭借其直接、高分辨率的台阶高度测量能力,在 FeMn/CoFeB 薄膜的厚度表征和沉积速率标定中发挥了不可替代的作用,为整个实验体系的定量化研究奠定了重要的计量基础。
本文系统研究了不同缓冲层与覆盖层材料对FeMn/CoFeB反铁磁/铁磁薄膜体系界面交换偏置效应的影响,旨在通过优化膜层结构以在室温下获得并调控更大的交换偏置场。
实验与方法
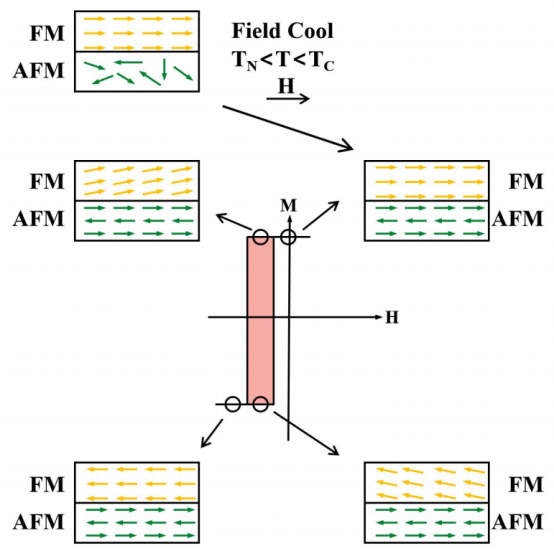
交换偏置建立过程示意图
台阶仪原理与参数
本研究采用Flexfilm探针式台阶仪(台阶法)对磁控溅射制备的薄膜进行厚度表征。台阶仪的工作原理是利用金刚石探针沿样品表面匀速扫描,探针在垂直方向的位移信号经电路放大后被记录,从而通过膜层与基底之间的台阶高度直接读取薄膜厚度。本研究所采用的薄膜厚度概念为"形状厚度",即薄膜两侧平均表面的间距,这是最接近直觉意义的膜厚定义,适用于对表面凹凸、岛状初始生长等实际情况的定量描述。
样品制备与前处理

直流磁控溅射原理

超高真空磁控溅射仪组成部分及腔内结构
所有薄膜均采用超高真空磁控溅射系统制备,本底真空度优于 5×10⁻⁵ Pa,溅射气体为 Ar,工作气压固定在 0.5 Pa。为获得可测量的台阶,采用掩模遮盖部分基底,在表面氧化的 [100] 单晶硅基片(氧化层厚度约 200 nm)上制备出具有明显台阶边缘的薄膜样品,以供探针横跨台阶区域进行扫描。用于台阶仪标定的样品包括 NiFeCr、Cu、FeMn、CoFeB 四种材料,溅射时间统一设定为 1800 s,以便在同一时间参数下测定各材料的沉积速率。FeMn 和 CoFeB 靶材采用直流溅射模式,Ta 靶采用射频溅射方式。溅射期间,在基片位置沿平行膜面方向施加约 280–300 Oe 的面内磁场,以诱导薄膜磁各向异性。基片在溅射前依次经过丙酮、无水乙醇、去离子水超声清洗(各 15–30 min),并用匀胶机甩干,以确保基底表面洁净、无影响台阶测量精度的污染物。
测试流程与误差控制
台阶仪测试在室温环境下进行,探针沿样品表面自基底裸露区域横向扫入薄膜覆盖区域,连续记录表面高度轮廓曲线。台阶高度由薄膜覆盖区域与裸露基底区域的平均高度差直接读取,即为薄膜形状厚度。通过将台阶高度除以对应溅射时间(1800 s),可计算出各材料在该工艺条件下的薄膜沉积速率(Å/s),该速率参数随后用于指导正式样品中各功能层厚度的定量控制。测量误差主要来自基底自身的表面粗糙度以及薄膜岛状生长阶段带来的厚度不均一性;本研究通过选用高平整度的硅基片来降低基底噪声对台阶信号的干扰。
各材料薄膜的沉积速率标定

磁控溅射制备的不同材料薄膜的台阶仪表面轮廓对比图,(a)NiFeCr、(b)Cu、(c)FeMn、(d)CoFeB,所有样品溅射时间均1800 s
在统一溅射时间(1800 s)和固定工艺参数(Ar 气压 0.5 Pa、本底真空 < 5×10⁻⁵ Pa)的条件下,四种材料均表现出较为平坦的薄膜表面和清晰的台阶边缘,具备良好的可测量性。整体沉积速率约为 1 Å/s,以此为基准,可精确推算出正式多层膜样品中各功能层的目标溅射时间,进而实现对 2 nm 至 20 nm 范围内各层厚度的定量控制。台阶仪的测量结果表明,各材料薄膜在该工艺窗口内具备较一致的成膜特性,为后续多层膜叠层厚度的精确设计提供了可靠依据。
台阶仪厚度数据对交换偏置研究的定量支撑
台阶仪的精确测厚直接决定了本研究中各厚度梯度系列实验的可靠性。在缓冲层厚度研究中,Cu 缓冲层从 5 nm 逐步增加至 20 nm,通过台阶仪标定的沉积速率可将各层厚度偏差控制在亚纳米量级。实验结果表明,Cu 缓冲层厚度在 5 nm ≤ tCu ≤ 8 nm 区间内,FeMn/CoFeB 的交换偏置场(Hex)从 305.56 Oe 快速增长至 504.84 Oe,在 tCu = 8 nm 时达到最大值;此后随缓冲层继续增厚,Hex 逐步趋于稳定,在 454.29 ± 10 Oe 范围内波动。这一非单调依赖关系——若无台阶仪对厚度的精确标定——在实验中将无法准确复现和解析,更无从找到最优 Cu 缓冲层厚度窗口。
在铁磁层(CoFeB)厚度梯度实验中,台阶仪标定的速率同样保证了 tCoFeB = 2、3、4、5 nm 各系列样品厚度的可控性。实验数据显示,随着 CoFeB 层厚从 2 nm 增至 5 nm,Hex 从约 305.56 Oe 降至 119.11 Oe,矫顽力(Hc)从 79.34 Oe 降至 24.45 Oe,与交换偏置作为界面效应、与铁磁层厚度成反比的理论预测高度吻合。这一规律能够被清晰提取,正是基于台阶仪厚度标定所带来的精确厚度管控。
覆盖层研究中的厚度精度需求
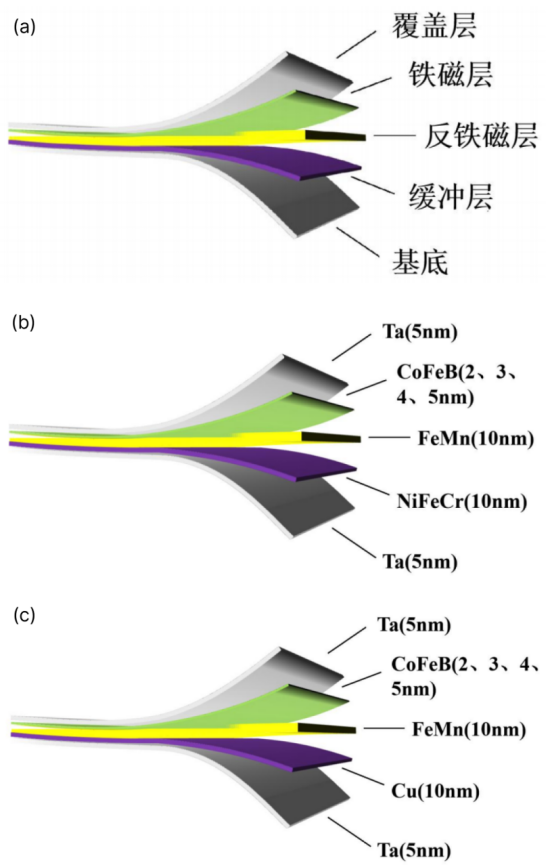
多层膜结构示意图
在覆盖层研究中,台阶仪标定同样不可或缺。以Ta(5 nm)/Cu(5 nm)/FeMn(10 nm)/CoFeB(2 nm)/Cu(t)/Ta(5 nm) 系列为例,Cu 覆盖层厚度从 1 nm 调变至 7 nm 时,Hex 和 Hc 均呈现出系统性变化:当 tCu = 5 nm 时,Hex 达到最大值 450.84 Oe,同时 Hc 仅为 25.6 Oe,展现出最优的综合磁性能。这一最优厚度窗口的识别,建立在台阶仪对各层厚度精确标定的基础之上,若厚度存在较大偏差,最优结构将被掩盖于数据散布之中,无法被准确定位。
本研究采用Flexfilm探针式台阶仪对磁控溅射制备的 NiFeCr、Cu、FeMn、CoFeB 四种薄膜材料进行了系统的表面轮廓扫描与厚度测量。结果所示,各材料在统一溅射时间(1800 s)、工作气压(0.5 Pa)条件下均呈现出清晰的台阶形貌,沉积速率约为 1 Å/s。台阶仪的精确测厚为整个 FeMn/CoFeB 薄膜交换偏置研究体系提供了关键的厚度计量基础:正是依托对各功能层厚度的纳米级精准控制,研究得以系统揭示 Cu 缓冲层厚度 tCu = 8 nm 时交换偏置场峰值(Hex = 504.84 Oe,350°C 退火后最高可达 540.31 Oe)、CoFeB 铁磁层厚度增加时 Hex 与 Hc 的协同衰减规律,以及 Cu/Ta 覆盖层结构在最优厚度下兼顾大交换偏置(450.84 Oe)与低矫顽力(25.6 Oe)的磁性能优化结果。台阶仪的应用将宏观磁学测量与微观结构设计联系起来,为 FeMn/CoFeB 体系的精准磁控提供了不可或缺的计量支撑。

技术支持:180-1566-6117
在半导体、光伏、LED、MEMS器件、材料等领域,表面台阶高度、膜厚的准确测量具有十分重要的价值,尤其是台阶高度是一个重要的参数,对各种薄膜台阶参数的精确、快速测定和控制,是保证材料质量、提高生产效率的重要手段。
✔ 配备500W像素高分辨率彩色摄像机
✔ 亚埃级分辨率,台阶高度重复性1nm
✔ 360°旋转θ平台结合Z轴升降平台
✔ 超微力恒力传感器保证无接触损伤精准测量
费曼仪器作为国内领先的薄膜厚度测量技术解决方案提供商,Flexfilm探针式台阶仪可以对薄膜表面台阶高度、膜厚进行准确测量,保证材料质量、提高生产效率。
原文参考:《不同缓冲层和覆盖层对 FeMn/CoFeB 薄膜体系交换偏置的影响》